2. 南昌大学 摩擦学重点实验室,南昌 330031
2. Key Laboratory of Tribology, Nanchang University, Nanchang 330031, China
蓝宝石单晶具有硬度高、熔点高、化学性质稳定、光学性能良好等诸多优点,广泛应用于军工及民用领域,如大规模集成电路、半导体照明及超导纳米结构薄膜等高科技产品的衬底材料[1]。
在蓝宝石衬底上生长半导体器件之前,必须降低其表面粗糙度,因其表面粗糙度大,容易吸附杂质且与生长在蓝宝石上的薄膜晶格匹配较差,所以蓝宝石衬底在使用前必须经过抛光处理以获得良好的表面形态。目前,国内外半导体加工行业多采用化学机械抛光(CMP)的方法对蓝宝石衬底材料进行最终的精加工表面处理,以满足其使用要求。如Merricks[2]对比了不同抛光液的抛光效果,Al2O3抛光液去除率较大,约3 μm/h。Aida等人[3]研究了不同pH值抛光液的抛光效果,去除率最高约2 μm/h,抛光后表面粗糙度为0.08 nm。Park和Athuek等人[4-5]研究不同粒径SiO2抛光液对蓝宝石抛光的影响,去除率最高为2.5 μm/h。国内从20世纪80年代开始研究蓝宝石抛光,WANG Y Z等人[6]对蓝宝石材料进行化学机械抛光+化学腐蚀后,得到粗糙度为0.23 nm的光滑无损伤表面。LIU Y L和NIU X H等[7-8]使用R(NH2)2pH调节剂与KOH比例为1:20时,蓝宝石去除率最高约3 μm/h,表面粗糙度为0.2 nm。HU X K等人[9]采用“微米级B4C研磨+纳米级SiO2抛光”对蓝宝石材料进行加工,去除率约2.4 μm/h,粗糙度为0.71 nm。YAN W X等[10-11]研究了SiO2磨料粒径、浓度及抛光液pH值对蓝宝石CMP的影响,去除率约为1.8 μm/h,粗糙度约0.2 nm。PAN G S研究不同粒径SiO2抛光液对蓝宝石抛光效果,还使用金属催化剂Fe-Nx/C来提高蓝宝石CMP的材料去除率,最大去除率为2.3 μm/h[12-14]。LEI H在SiO2中掺杂Cu、Ce、La等[15-18],LU J制备核壳结构氧化铝/钛酸、金刚石/β-FeOOH复合磨粒[19-20],对蓝宝石进行抛光,可提高材料去除率并降低粗糙度,去除率约1.5 μm/h,粗糙度约1 nm。
由于蓝宝石硬度为莫氏9级,仅次于金刚石,加上化学性质非常稳定,难以去除,造成蓝宝石CMP加工效率较低,从而延长了抛光时间,大幅增加成本。超声抛光可提高硬脆性材料如光纤[21]、硅片[22]、SiC[23]等的加工效率和精度。因此自主研制了超声弯曲振动辅助化学机械抛光(UFV-CMP)装置,在抛光头做旋转运动的同时,引入水平和竖直两个方向的超声振动,经抛光试验证明,可提高蓝宝石抛光效率近1倍,同时抛光后表面粗糙度低于0.1 nm[24-25]。抛光液和抛光垫在蓝宝石超声化学机械抛光过程中起着营造抛光环境、提供抛光机械力等非常重要的作用。因此,文中基于自制的超声弯曲振动辅助化学机械抛光装置,通过实际抛光试验,研究金刚石、氧化铝和二氧化硅3种抛光液,以及聚氨酯、IC1000和IC1000/SubaⅣ复合垫3种抛光垫,对蓝宝石衬底的抛光效果,包括蓝宝石材料去除率和抛光后表面粗糙度,确定最佳的抛光液和抛光垫。并从物理参数、表面形貌、化学反应、超声振动的作用等方面解释抛光磨粒和抛光垫特性对蓝宝石材料去除和原子级光滑表面形成的影响。
1 试 验 1.1 超声弯曲振动辅助化学机械抛光试验装置文中使用的超声弯曲振动辅助化学机械抛光装置,与传统的超声复合抛光装置不同,其特点是在典型的化学机械抛光系统的基础上,使主动旋转的抛光头产生超声频率的弯曲振动,即同时具有水平和竖直两个方向的超声振动。抛光头为阶梯式圆盘,其独特的结构可将变幅杆的纵向振动转换为弯曲振动。以往的超声复合抛光工具的尺寸往往小于被加工工件的尺寸,不能一次性加工整个工件表面,而此装置可以一次性加工整个蓝宝石材料的表面,效率更高。一般超声抛光装置只有抛光盘主动旋转而抛光头不旋转或者被动旋转,而此装置中抛光头和抛光盘分别主动旋转,有利于提高加工的精度和质量。超声弯曲振动圆盘即抛光头是超声辅助化学机械抛光装置的核心部件,其弯曲振动由超声振动信号通过半波长变幅杆在圆盘中心激励产生。平板圆盘弯曲振动时会出现若干个节圆,在节圆的两边由于振动相位相反,会产生声波的相消干涉,造成部分辐射超声相互抵消,从而降低了超声能量。为消除这种不良影响,可将圆盘做成阶梯状。其原理是:在节圆一侧做出厚度为超声半波长的阶梯后,相当于声波变化了π相位,使节圆两侧超声振动变成了同向振动,增大了向外辐射的能量。阶梯式超声弯曲振动圆盘结构如图1所示。

|
| 图 1 阶梯式超声弯曲振动圆盘 Fig. 1 Stepped disc with ultrasonic bending vibration |
试验用蓝宝石衬底直径为2英寸(约50.8 mm),厚度约为430 μm,晶向为C向即(0001)。蓝宝石衬底抛光前后,应进行超声清洗处理,以去除其表面的污渍,以免影响抛光效果。抛光过程中超声弯曲振动的抛光头在一定的抛光压力下与抛光液、抛光垫接触,与抛光垫同向同速转动,实现蓝宝石材料超声、化学、机械复合抛光。蓝宝石衬底在抛光前后使用精度为0.1 mg的电子天平称其质量变化,换算为厚度去除率。蓝宝石抛光前后的表面形貌用原子力显微镜(AFM)进行观测。
1.3 抛光液抛光液是蓝宝石抛光的关键因素之一,直接影响抛光效率和抛光后表面的质量。抛光液中的化学成分,影响化学反应过程,并提供腐蚀、溶解等作用;抛光液中的研磨颗粒,提供机械研磨或者化学反应催化剂作用,影响反应产物的去除速率和抛光后表面质量。目前,蓝宝石常用的含磨粒抛光液主要有3种:金刚石、氧化铝和二氧化硅抛光液,为此就这3种抛光液在UFV-CMP工艺下对蓝宝石材料抛光效果进行对比,确定适合UFV-CMP工艺的抛光液。3种磨粒抛光液的参数见表1。
| Abrasive | Size / nm | Concentration / % | pH |
| Diamond | 280 | 10 | 6.4 |
| Alumina | 170 | 10 | 9.9 |
| Silica | 70 | 15 | 10.9 |
抛光垫也是蓝宝石抛光的关键因素之一,抛光垫可存储抛光液并将其输送到整个抛光区域,营造抛光所需的机械和化学环境,并将抛光产物带走。抛光垫的物理力学性以及表面结构特等因素直接影响抛光的效率和质量。
根据抛光垫表面微观结构,常用于CMP的抛光垫可分4种:①聚酯毛毡;②多孔性合成革;③多孔聚氨酯;④表面没有微孔、有沟槽的聚氨酯板。4种抛光垫中,应用最为广泛的是第三种和第一种,代表产品为IC1000和SubaⅣ系列抛光垫。试验选用3种不同的抛光垫:表面多孔无沟槽的聚氨酯抛光垫、IC1000抛光垫、由IC1000和SubaⅣ叠加在一起的复合型抛光垫,对蓝宝石衬底在UFV-CMP工艺下进行抛光试验,通过对比抛光效果来确定适合于蓝宝石UFV-CMP的抛光垫。3种抛光垫的参数见表2,其表面形貌和结构由扫描电镜(SEM)进行观测。
| Pad | Polyurethane | IC1000 | SubaⅣ |
| Material | Polyurethane | Polyurethane | Non-woven fabrics |
| Shore hardness | 75 | 60 | 42.8 |
| Thickness / mm | 1.5 | 1.25 | 1.28 |
| Compression ratio | 0.8 |
分别使用表1中所示金刚石、氧化铝和二氧化硅3种不同磨粒抛光液,在相同抛光条件下,对蓝宝石衬底进行超声弯曲振动辅助化学机械抛光,然后比较其抛光效果。试验用抛光垫为聚氨酯抛光垫,抛光头与抛光垫转速为80 r/min,抛光压力为7.0 Psi(1 Psi=6.9 kPa),抛光液流速为90 mL/min。对蓝宝石衬底在抛光前后进行称重,由去除质量换算得到的材料去除率如图2所示。

|
| 图 2 不同抛光磨粒对蓝宝石衬底的去除率 Fig. 2 Material removal rates of sapphire under different abrasive particles |
由图2可以看出氧化铝抛光液的去除率最大,为3.8 μm/h;二氧化硅抛光液的去除率次之,为3.2 μm/h;金刚石抛光液的去除率远小于氧化铝和二氧化硅抛光液的去除率,仅为0.3 μm/h。这是因为使用氧化铝抛光液时,氧化铝颗粒和蓝宝石基体表面会同时生成水合层Al2O3∙H2O、Al(OH)3[5, 26](如式(1)(2)所示),两水合层在机械-化学作用下吸附在一起,再被撕裂,且氧化铝颗粒的硬度与基体相当,这都有助于提高蓝宝石的去除率。
使用二氧化硅抛光液抛光蓝宝石材料时,许多研究人员认为抛光液中的二氧化硅颗粒会与蓝宝石基体在局部高温高压条件下,发生化学反应生成一些硬度较低的高岭土Al2Si2O7∙2H2O、蓝晶石Al2SiO5等[14, 16, 26](如式(3)(4)所示)。Vovk使用X射线光电子能谱分析(XPS)研究了SiO2抛光液对蓝宝石进行CMP后的反应物,认为生成了Al2SiO5且反应层厚度约为20.5 nm[4]。PAN G S使用原子力显微镜(AFM)和XPS研究了α向蓝宝石抛光后表面形成的化学产物,指出生成物为Al2Si2O7∙2H2O且其去除是在六角密集堆积的Al−O层(原子梯田)进行的[27]。LEI H通过分析、测试认为蓝宝石CMP过程中产生的反应物为Al2SiO5、水合物等与复合磨粒反应的产物[15-18]。并且这些反应层与蓝宝石基体结合力比较低,比较容易被去除,因此可得到较高的去除率。
且超声振动本身及其引起的空化现象会提高抛光区域的局部温度,升温会影响二氧化硅颗粒、水与蓝宝石表面的反应活性和反应速率。Arrhenius方程可用来反映化学反应速率与温度之间的关系,方程如式(5)所示[28]。
式(5)中,K为化学反应速率,A为Arrhenius常数,Ea为最小活化能,R为摩尔气体常数,T为开氏温度。随着温度T的升高,蓝宝石分子从稳定状态变为活性状态的最小活化能Ea减小。因此根据Arrhenius方程,超声振动引起的升温会使式(3)和式(4)所示的化学反应速率增加,相同时间内生成更多较软反应产物,进一步提高二氧化硅抛光液对蓝宝石材料的去除效率。而金刚石颗粒不会与基体发生反应生成较软物质,所以去除率最低。
图3为蓝宝石衬底在超声弯曲振动辅助化学机械抛光(UFV-CMP)工艺下,金刚石、氧化铝和二氧化硅抛光液流速为90 mL/min,抛光压力7.0 Psi,抛光头和抛光盘均以80 r/min的转速逆时针同向转动时,抛光后表面使用AFM观测得到的二维和三维形貌。
由图3(a)可看到,金刚石抛光液抛光后的蓝宝石表面有许多很深的划痕,表面质量最差。由图3(b)可看到,氧化铝抛光液抛光后的蓝宝石表面也有划痕,但与图3(a)所示金刚石抛光液造成的表面相比,氧化铝抛光液造成的划痕较少、较浅。对比图3(b)(c)可看到,金刚石、氧化铝抛光液抛光后的蓝宝石表面都有非常明显的划痕,表面质量很差,而二氧化硅抛光液抛光后的蓝宝石表面光滑、无划痕。
这是因为使用二氧化硅抛光液抛光蓝宝石材料时,抛光液中的二氧化硅颗粒不但会与蓝宝石基体在局部高温高压条件下生成一些硬度较低、容易被去除的物质,而且二氧化硅颗粒硬度小于基体硬度且形状为球形、分布均匀、无团聚(如图4(a)所示),不易在蓝宝石表面产生划痕,可得到光滑无损伤的表面;使用氧化铝抛光液时,虽然氧化铝颗粒可以和蓝宝石基体表面会同时生成水合层,但氧化铝颗粒硬度与基体相当,且形状不规则、有棱角、有团聚(如图4(b)所示),易在蓝宝石表面产生划痕;而金刚石颗粒不仅不会与基体发生反应生成较软物质,且硬度大于蓝宝石基体,形状不规则、有棱角、团聚现象严重(如图4(c)所示),故极易在蓝宝石表面产生较多、较深划痕。

|
| 图 4 二氧化硅、氧化铝和金刚石颗粒SEM形貌 Fig. 4 SEM images of silica, alumina and diamond particles |
在传统蓝宝石CMP中,抛光压力可认为是均匀分布在接触磨粒上,接触磨粒在一定抛光压力的作用下滑擦、犁削蓝宝石材料表面,从而造成材料的去除;而用UFV-CMP工艺来抛光蓝宝石材料时,作用在接触颗粒上的力除了施加的一定抛光压力外,还有超声弯曲振动带来的作用力。超声弯曲振动可分解为水平和竖直两个方向的分量,由超声振动方程结合冲量定理可得,竖直方向的超声振动所引起的蓝宝石表面和接触磨粒之间的作用力为[25]:
式(6)中,
且在UFV-CMP抛光蓝宝石工艺中,虽然磨粒在基体表面运动轨迹的整体形状与传统CMP类似,但水平方向的超声振动使磨粒在蓝宝石表面以超声频率往返重复划过,运动轨迹的长度明显增大,且形状由光滑的弧形变化为锯齿形。超声振动会增加金刚石颗粒与衬底表面的接触力,增长颗粒在基体表面的运动轨迹长度,这些作用虽然可提高蓝宝石去除率,但对硬度大于蓝宝石基体的金刚石磨粒和与基体硬度相当的氧化铝磨粒,会损伤蓝宝石表面,造成较多且深的划痕(见图3(a)(b))。
综合考虑3种抛光液对蓝宝石材料的材料去除率和抛光后表面质量的影响,二氧化硅抛光液的去除率3.2 μm/h接近氧化铝抛光液的去除率3.8 μm/h,远大于金刚石抛光液的去除率0.3 μm/h,且其抛光后的蓝宝石表面光滑、无划痕等损伤,抛光效果最好,故在UFV-CMP工艺下,应使用二氧化硅抛光液对蓝宝石衬底材料进行抛光。
2.2 不同抛光垫的抛光效果分别使用表2中所示3种不同抛光垫,在相同抛光条件下,对蓝宝石衬底进行超声弯曲振动辅助化学机械抛光试验,然后比较其抛光效果。试验所用聚氨酯抛光垫与IC1000抛光垫同属第三种抛光垫,都是由微孔聚氨酯材料构成,不同的是聚氨酯抛光垫表面没有沟槽而IC1000抛光垫表面开有网格型沟槽。且由表2可知,聚氨酯抛光垫的肖氏硬度为75、厚度为1.5 mm,大于IC1000抛光垫的肖氏硬度60及厚度1.25 mm,SubaⅣ抛光垫厚度为1.28 mm,与IC1000抛光垫厚度接近,但其肖氏硬度最小,仅为42.8。聚氨酯、IC1000、SubaⅣ抛光垫的扫描电镜形貌见图5。
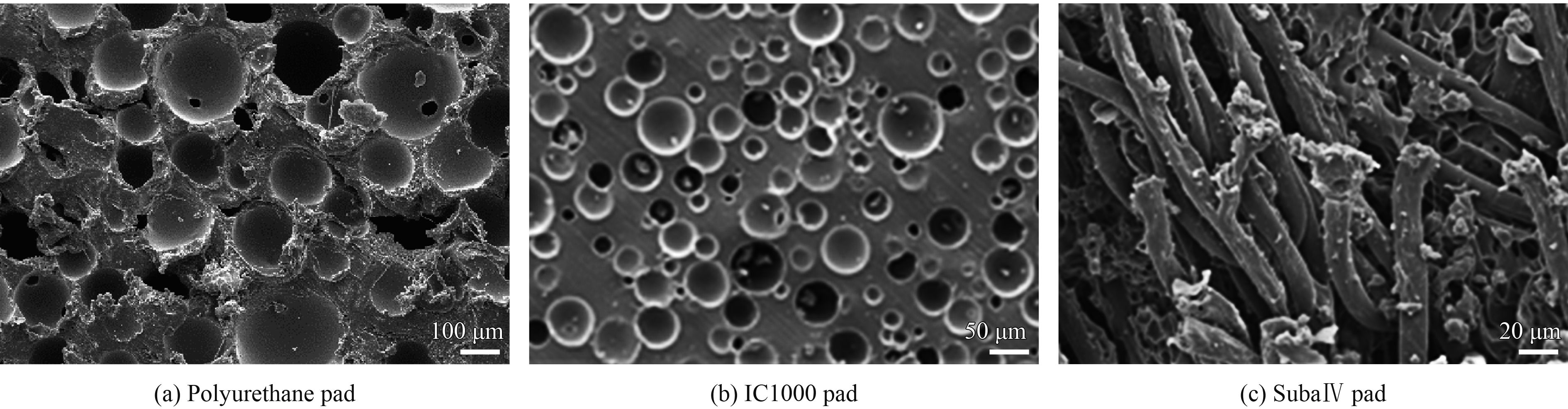
|
| 图 5 聚氨酯、IC1000、SubaⅣ抛光垫SEM形貌 Fig. 5 SEM images of polyurethane, SubaⅣ and IC1000 pad |
图5(b)为IC1000抛光垫的表面形貌,由图可看到IC1000抛光垫的表面显微结构与聚氨酯抛光垫(图5(a))类似,其表面有许多孔洞,孔洞的平均直径多数在40 μm左右,而聚氨酯抛光垫表面最小的孔洞直径在70 μm左右,最大的孔洞直径在600 μm左右,远大于IC1000抛光垫表面的孔洞直径。
图5(c)为SubaⅣ抛光垫的表面形貌,由图可看到SubaⅣ抛光垫表面有许多聚酯毛毡纤维构成,纤维直径在20 μm左右,纤维结构使得SubaⅣ抛光垫相对较软。IC1000/SubaⅣ复合垫中,上层即与蓝宝石衬底接触的为较硬的IC1000抛光垫,下层是较软的SubaⅣ抛光垫,这种复合垫兼有IC1000和SubaⅣ的优点,兼顾平坦性和均匀性的要求。经接触式表面形貌仪测量得到IC1000抛光垫表面粗糙度为3.77 μm,而聚氨酯抛光垫的表面粗糙度为32.38 μm,约为IC1000抛光垫表面粗糙度的9倍。
图6为抛光压力7.0 Psi(1 Psi=6.9 kPa)、抛光头和抛光盘均以80 r/min的转速同向转动,二氧化硅抛光液流速90 mL/min时,聚氨酯、IC1000、IC1000/SubaⅣ复合垫3种抛光垫在UFV-CMP工艺下对蓝宝石材料的去除率。可见,聚氨酯抛光垫的去除率最大,为3.2 μm/h;IC1000抛光垫的去除率为1.9 μm/h,约为聚氨酯抛光垫去除率的60%;IC1000/SubaⅣ复合垫的去除率最小,只有1.6 μm/h,为聚氨酯抛光垫去除率的一半。

|
| 图 6 不同抛光垫对蓝宝石衬底去除率 Fig. 6 Material removal rates of sapphire under different polishing pads |
由抛光垫的表面显微结构(图5)、表面粗糙度及抛光垫参数(表2)可知,聚氨酯抛光垫的硬度以及表面粗糙度都远大于IC1000和IC1000/SubaⅣ复合垫,其对蓝宝石表面的机械作用较强,有利于提高抛光效率;且由于粗糙度大,在抛光垫粗糙峰支撑下的二氧化硅颗粒对蓝宝石表面的作用力也越大,单颗磨粒的去除体积增大;聚氨酯抛光垫的微孔直径较大,可容纳更多的抛光液,更多的抛光液参与蓝宝石材料的去除,增强了化学作用,故其对蓝宝石材料的去除率最高。IC1000抛光垫的硬度、表面粗糙度以及表面孔洞直径都小于聚氨酯抛光垫,抛光过程中提供的机械、化学作用较弱,故其去除率低于聚氨酯抛光垫的去除率。IC1000/SubaⅣ复合垫的硬度最低,抛光过程中提供的机械作用最弱,故其去除率最低。
在相同抛光条件下,使用聚氨酯、IC1000、IC1000/SubaⅣ复合抛光垫抛光后的蓝宝石表面经AFM观测后的形貌如图3(c)和图7所示。
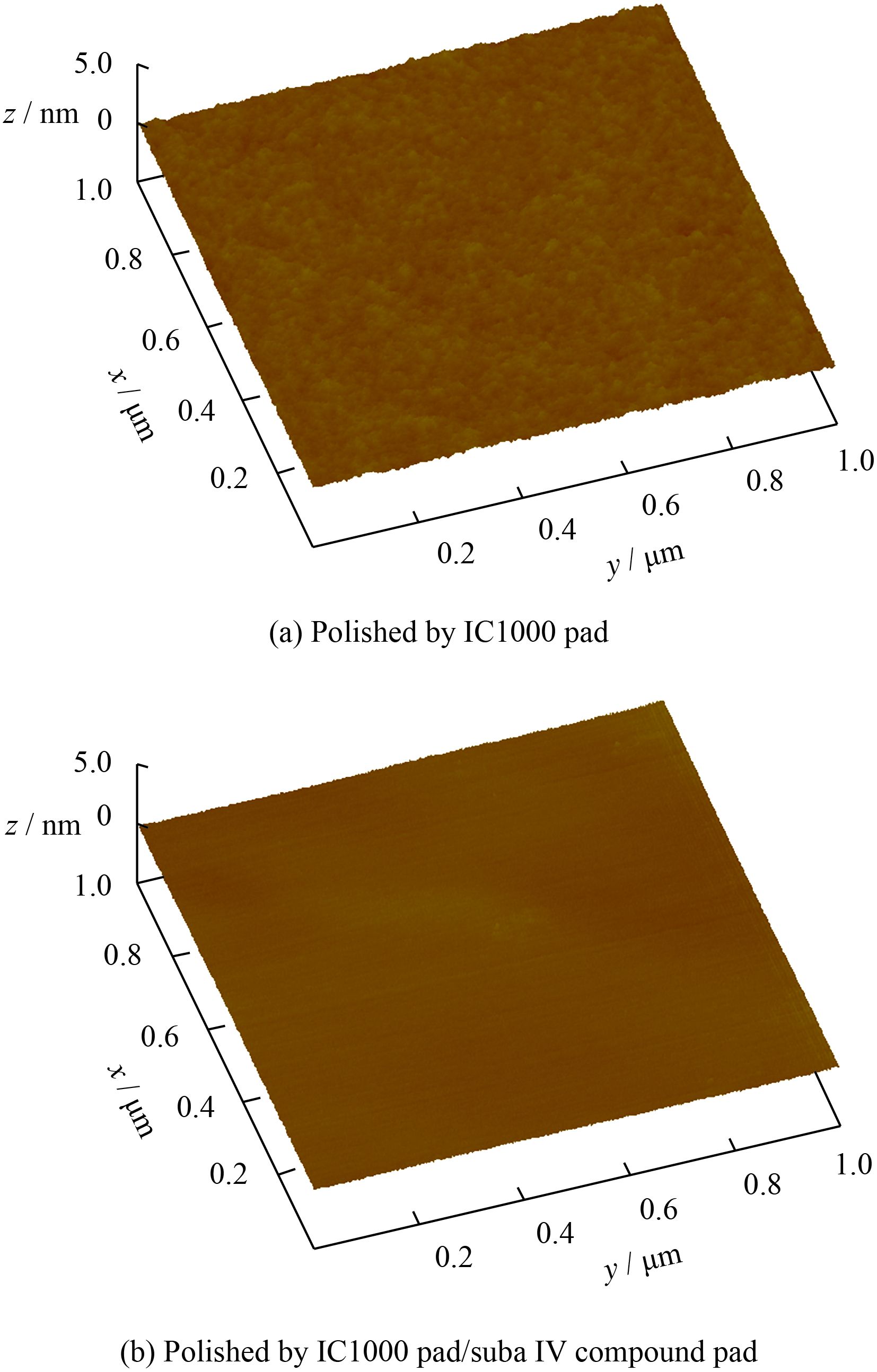
|
| 图 7 IC1000和IC1000/SubaⅣ复合垫抛光后蓝宝石表面AFM形貌 Fig. 7 AFM surface images of sapphire polished by IC1000 and IC1000/SubaⅣ compound pad |

|
| 图 3 抛光液抛光后蓝宝石表面AFM形貌 Fig. 3 AFM surface images of sapphire polished by the diamond, alumina and silica slurry |
由AFM测量结果可知,蓝宝石经聚氨酯、IC1000,IC1000/SubaⅣ复合抛光垫抛光后表面均光滑无损伤。3种抛光垫在UFV-CMP工艺下抛光蓝宝石材料后的粗糙度Ra大小关系为:IC1000/SubaⅣ复合垫(0.07 nm)< IC1000(0.09 nm)< 聚氨酯(0.10 nm)。因为与聚氨酯抛光垫相比,IC1000抛光垫表面开有网格形沟槽,抛光过程中蓝宝石基片易与抛光垫之间形成流体膜,储存、运送抛光液的能力增强,磨粒分布更均匀,并改善了抛光压力分布的均匀性,可提高加工质量,降低表面粗糙度;IC1000/SubaⅣ复合垫上层为IC1000抛光垫,下层为SubaⅣ抛光垫,兼具了两种抛光垫的优点,存储抛光液的效果更好,压缩性更大,可获得更高的表面质量和较低的粗糙度。
综合考虑3种抛光垫对蓝宝石材料的材料去除率和抛光后表面质量的影响,在相同的抛光条件下,聚氨酯抛光垫抛光后的蓝宝石表面光滑、无损伤,粗糙度为0.10 nm,略高于IC1000抛光后的蓝宝石表面粗糙度0.09 nm和IC1000/SubaⅣ复合垫抛光后的蓝宝石表面粗糙度0.07 nm;但其对蓝宝石材料的去除率为3.2 μm/h;远大于IC1000抛光垫的去除率1.9 μm/h和IC1000/SubaⅣ复合垫的去除率1.6 μm/h,故在UFV-CMP工艺下,应使用聚氨酯抛光垫对蓝宝石衬底材料进行抛光。
3 结 论(1) 金刚石、氧化铝、二氧化硅3种磨粒抛光液对蓝宝石衬底进行超声弯曲振动辅助化学机械抛光:二氧化硅抛光液的去除率3.2 μm/h接近氧化铝抛光液的去除率3.8 μm/h,远大于金刚石抛光液的去除率0.3 μm/h,且其抛光后的蓝宝石表面光滑、无划痕等损伤,抛光效果最好。
(2) 聚氨酯、IC1000、IC1000/SubaⅣ复合垫3种抛光垫对蓝宝石衬底进行超声弯曲振动辅助化学机械抛光:聚氨酯抛光垫抛光后的蓝宝石表面光滑、无损伤,粗糙度Ra为0.10 nm,略高于IC1000抛光后的蓝宝石表面粗糙度Ra为0.09 nm和IC1000/SubaⅣ复合垫抛光后的蓝宝石表面粗糙度Ra为0.07 nm;但其对蓝宝石材料的去除率为3.2 μm/h;远大于IC1000抛光垫的去除率1.9 μm/h和IC1000/SubaⅣ复合垫的去除率1.6 μm/h。
(3) 蓝宝石衬底超声弯曲振动辅助化学机械抛光应使用二氧化硅抛光液和表面多孔、无沟槽的聚氨酯抛光垫,可同时获得高材料去除率和原子级光滑表面。
| [1] | KHATTAK C P, SHETTY R, SCHWERDTFEGER C R, et al. World's largest sapphire for many applications[J]. Journal of Crystal Growth, 2016, 452: 44-48. |
| 点击浏览原文 | |
| [2] | MERRICKS D. Alumina abrasives for sapphire substrate polishing[J]. ECS Transactions, 2011, 34(1): 1035-1039. |
| [3] | AIDA H, DOIT, TAKEDA H, et al. Ultraprecision CMP for sapphire, GaN and SiC for advanced optoelectronics materials[J]. Current Applied Physics, 2012, 12: 41-46. |
| 点击浏览原文 | |
| [4] | VOVK E A, BUDNIKOV A T, DOBROTVORSKAYA M V, et al. Mechanism of the interaction between Al2O3 and SiO2 during the chemical mechanical polishing of sapphire with silicon dioxide[J]. Journal of Surface Investigation X.-Ray, 2012, 6: 115-121. |
| 点击浏览原文 | |
| [5] | ATHUEK N B, YOSHIMOTO Y, SAKAI K, et al. Study on effect of the surface variation of colloidal silica abrasive during chemical mechanical polishing of sapphire[J]. Japanese Journal of Applied Physics, 2017, 56: 07KB01. |
| 点击浏览原文 | |
| [6] | WANG Y Z, LIU S H, PENG G L, et al. Effects of surface treatment on sapphire substrates[J]. Journal of Crystal Growth, 2005, 274: 241-245. |
| 点击浏览原文 | |
| [7] | WANG J C, NIU X H, ZHAO X, et al. Effect of a pH regulator on sapphire substrate CMP[J]. ECS Journal of Solid State Science and Technology, 2017, 6(12): 832-838. |
| 点击浏览原文 | |
| [8] |
贾少华, 刘玉岭, 王辰伟, 等. 化学机械平坦化材料对蓝宝石抛光速率与粗糙度的影响[J]. 功能材料, 2016, 47(2): 2242-2246
JIA S H, LIU Y L, WANG C W, et al. Effect of chemical mechanical planarization material on sapphire polishing rate and roughness[J]. Journal of Functional Materials, 2016, 47(2): 2242-2246 (in Chinese) |
| 点击浏览原文 | |
| [9] | HU X K, SONG Z T, PAN Z C, et al. Planarization machining of sapphire wafers with boron carbide and colloidal silica as abrasives[J]. Applied Surface Science, 2009, 255: 8230-8234. |
| 点击浏览原文 | |
| [10] | YAN W X, ZHANG Z F, GUO X H, et al. The effect of pH on sapphire chemical mechanical polishing[J]. ECS Journal of Solid State Science and Technology, 2015, 4: 108-111. |
| 点击浏览原文 | |
| [11] | ZHANG Z F, ZHANG W J, ZhANG S D, et al. Study on chemical mechanical polishing performances of sapphire wafer (0001) using silica-based slurry[J]. ECS Journal of Solid State Science and Technology, 2017, 6(10): 723-727. |
| 点击浏览原文 | |
| [12] | ZHOU Y, PAN G S, GONG H, et al. Characterization of sapphire chemical mechanical polishing performances using silica with different sizes and their removal mechanisms[J]. Colloids and Surfaces A: Physicochemical and Engineering Aspects, 2017, 513: 153-159. |
| 点击浏览原文 | |
| [13] | XU L, ZOU C L, SHI X L, et al. Fe-Nx/C assisted chemical-mechanical polishing for improving the removal rate of sapphire[J]. Applied Surface Science, 2015, 343: 115-120. |
| 点击浏览原文 | |
| [14] | XU L, ZHANG X, KANG C X, et al. Preparation of a novel catalyst (SoFeIII) and its catalytic performance towards the removal rate of sapphire substrate during CMP process[J]. Tribology International, 2018, 120: 99-104. |
| 点击浏览原文 | |
| [15] | LEI H, HUANG L Q, GU Q. Synthesis of Zn-doped colloidal SiO2 abrasives and their applications in sapphire chemical mechanical polishing slurry[J]. Journal of Materials Science: Materials in Electronics, 2017, 28: 1229-1237. |
| 点击浏览原文 | |
| [16] | ZHANG B C, LEI H, CHEN Y. Preparation of Ag2O modified silica abrasives and their chemical mechanical polishing performances on sapphire[J]. Friction, 2017, 5(4): 429-436. |
| 点击浏览原文 | |
| [17] | LIU T T, LEI H. Nd3+-doped colloidal SiO2 composite abrasives: Synthesis and the effects on chemical mechanical polishing (CMP) performances of sapphire wafers[J]. Applied Surface Science, 2017, 413: 16-26. |
| 点击浏览原文 | |
| [18] | WANG X, LEI H, CHEN R L. CMP behavior of alumina/metatitanic acid core-shell abrasives onsapphire substrates[J]. Precision Engineering, 2017, 50: 263-268. |
| 点击浏览原文 | |
| [19] | LU J, XU Y C, ZHANG D Y, et al. The synthesis of the core/shell structured diamond/akageneite hybrid particles with enhanced polishing performance[J]. Materials, 2017, 10(6): 673. |
| 点击浏览原文 | |
| [20] | XU Y C, LU J, XU X P. Study on planarization machining of sapphire wafer with soft-hard mixed abrasive through mechanical chemical polishing[J]. Applied Surface Science, 2016, 389: 713-720. |
| 点击浏览原文 | |
| [21] |
陈涛, 刘德福, 佘亦曦, 等. 光纤阵列的超声椭圆振动辅助化学机械抛光[J]. 中国表面工程, 2016, 29(3): 132-138
CHEN T, LIU D F, SHE Y X, et al. Ultrasonic elliptical vibration assisted chemical mechanical polishing for fiber array[J]. China Surface Engineering, 2016, 29(3): 132-138 (in Chinese) |
| 点击浏览原文 | |
| [22] |
曾一凡, 杨卫平, 吴勇波, 等. 超声振动辅助固结磨粒抛光硅片表面形成机理及实验[J]. 中国机械工程, 2016, 23: 3208-3214
ZENG Y F, YANG W P, WU Y B, et al. Mechanism of surface formation of silicon wafer processed by fixed abrasive polishing with assistance of ultrasonic vibration and experiments[J]. China Mechanical Engineering, 2016, 23: 3208-3214 (in Chinese) |
| 点击浏览原文 | |
| [23] | ZHAO Q L, SUN Z Y, GUO B. Material removal mechanism in ultrasonic vibration assisted polishing of micro cylindrical surface on SiC[J]. International Journal of Machine Tools and Manufacture, 2016, 103: 28-39. |
| 点击浏览原文 | |
| [24] | XU W H, LU X C, PAN G S, et al. Ultrasonic flexural vibration assisted chemical mechanical polishing for sapphire substrate[J]. Applied Surface Science, 2010, 256: 3936-3940. |
| 点击浏览原文 | |
| [25] | XU W H, LU X C, PAN G S, et al. Effects of the ultrasonic flexural vibration on the interaction between the abrasive particles, pad and sapphire substrate during chemical mechanical polishing (CMP)[J]. Applied Surface Science, 2011, 257: 2905-2911. |
| 点击浏览原文 | |
| [26] | YIN D, NIU X H, ZHANG K, et al. Preparation of MgO doped colloidal SiO2 abrasive and their chemical mechanical polishing performance on c-, r- and a-plane sapphire substrate[J]. Ceramics International, 2018, 44(12): 14631-14637. |
| 点击浏览原文 | |
| [27] | SHI X L, PAN G S, ZHOU Y, et al. A study of chemical products formed on sapphire (0001) during chemical-mechanical polishing[J]. Surface & Coatings Technology, 2015, 270: 206-220. |
| 点击浏览原文 | |
| [28] | GUTSCHE H W, MOODY J W. Polishing of sapphire with colloidal silica[J]. Journal of The Electrochemical Society, 1978, 125(1): 136-138. |
| 点击浏览原文 |



