2. 中国船舶重工集团公司 第七一九研究所,武汉 430064
2. No.719 Research Institute, China Shipbuilding Industry Corporation, Wuhan 430064
微波等离子体法(Microwave plasma chemical vapor deposition, MPCVD)具有等离子体密度较高、无极放电、无污染等优点,是制备高质量大面积金刚石膜的首选方法[1]。微波功率、沉积气压、基底温度和碳源浓度被认为是影响MPCVD金刚石质量和生长速率的重要参数,并得到了广泛研究[1-3]。
气体流量的改变也会对MPCVD金刚石膜表面形貌、质量和生长速率产生影响。Celii等人[4]研究表明,改变氢气流量,金刚石膜质量和晶粒取向会明显改变,同时等离子体内的活性基团的含量也会明显改变。Ralchenko等人[5]研究表明,氢气流量过高或过低都不利于金刚石膜的生长,在中间氢气流量下,300 cm3/min时,金刚石膜质量最佳。Chen等人[6]研究表明,氢气流量的改变对金刚石膜的质量、表面形貌和生长速率都会产生明显影响。Su等人[7]则在一种新型穹顶型单模MPCVD装置中对气体流量改变产生的影响进行了研究,并提出了一个“two-folded”理论对金刚石膜质量和生长速率的变化进行了解释,在氢气流量为100 cm3/min时金刚石膜质量最佳。不同研究者所得的结果不同,主要是由于所使用的微波等离子体装置不同。
金刚石膜的质量和均匀性受沉积表面基团种类、含量和能量高低直接影响。Sternschult等人[8]所得等离子体质谱结果表明,基片温度较低时金刚石生长的主导基团为CHx,而基片温度较高时金刚石生长的主导基团为C2Hx。Jie Ma等人[9]的红外激光吸收谱结果表明,CH4和C2H2在富氢环境中离解和转换的机理不同,主要受H原子含量和能量影响。马志斌等人[10]采用发射光谱技术对金刚石生长进行了研究,结果表明CH4浓度上升可促进等离子体离解,但活性基团空间分布均匀性下降。因此生长条件的变化会对金刚石膜表面基团种类和分布造成影响,目前还没有关于氢气流量的改变对金刚石膜生长面活性基团影响的系统报道。
文中使用新型多模MPCVD装置对氢气流量改变对等离子电子密度、温度大小及活性基团的分布进行相关研究,以期实现直径100 mm的大面积金刚石膜的高速均匀沉积。
1 试 验 1.1 试样制备使用频率为2.45 GHz微波等离子体装置进行大面积金刚石膜的沉积,图1为MPCVD装置示意图。MPCVD装置由实验室自主研发,腔体尺寸如图1所示。MPCVD装置最高输出功率为10 kW,可产生最大直径200 mm的等离子体球。MPCVD装置采用多模谐振腔设计,通过TM01和TM02两种电磁场在沉积基底上互相叠加产生大面积等离子体球,以实现大面积金刚石膜的沉积。使用直径为100 mm,厚度为3 mm,表面粗糙度为0.2 μm的钼片作为沉积基片。
试验前对Mo基片进行预处理:首先,在丙酮和酒精中分别进行超声处理,各15 min;然后,将Mo基片放入金刚石粉(直径0.5 μm)悬浮液中进行1 h的超声处理;最后,分别使用酒精和去离子水进行超声处理,各10 min,使用氮气吹干,再放入沉积腔体中。所使用的反应气体为纯度为99.999%的氢气和99.99%的甲烷。研究中,只改变氢气的流量,其它工艺参数保持不变,具体如表1所示。

|
| 图 1 多模MPCVD装置示意图 Figure 1 Schematic diagram of the overmoded MPCVD device |
| Parameters | Value |
| Microwave power / kW | 5.0 |
| Gas pressure / kPa | 15.0 |
| Substrate temperature / ℃ | 980 |
| CH4/H2 | 0.02 |
| Hydrogen flow rate / (cm3·min−1) | 50−800 |
| Time / h | 5 |
采用计算机模拟对MPCVD装置内的气体流场进行模拟。采用Ocean Optics公司制造,Maya2000型高灵敏度背照式FF-CCD光谱仪进行等离子体光谱(Optical emission spectroscopy,OES)的测量,光谱仪测量范围为200~1 100 nm,最佳光学分辨为0.035 nm,测试积分时间为100 ms。使用扫描电子显微镜(Scanning electron microscopy,SEM,JSM-5510LV,Japan)对金刚石膜的表面形貌进行表征,测试中扫描光斑直径保持在16~24 μm。使用拉曼光谱(Raman,DXR,USA)对金刚石膜的质量进行表征,Ar激光为测试激光,波长为633 nm。
2 多模MPCVD装置流场模拟结果与讨论利用navier-stokes方程(1)和(2)对多模MPCVD装置进行气体流场模拟:
其中,μ为流体黏度,u为流体速度,ρ为流体密度,p为压力。由于混合气体中甲烷浓度较低,因此采用纯氢组分作为模拟气体,气体温度为3 000 K,腔壁温度为20 ℃。边界条件为:① 腔壁为无滑移边界;② 出口边界的无流动静压10 Pa。
图2(a)(b)(c)分别为气体流量为100、300和500 cm3/min时多模MPCVD装置内的气体流速分布图。从图2可知,气体进入腔体后均匀对称的到达基底表面,然后离开腔体。气体流量上升提高了气体流速,流场分布没有改变,说明多模MPCVD装置具有较好的流场稳定性。
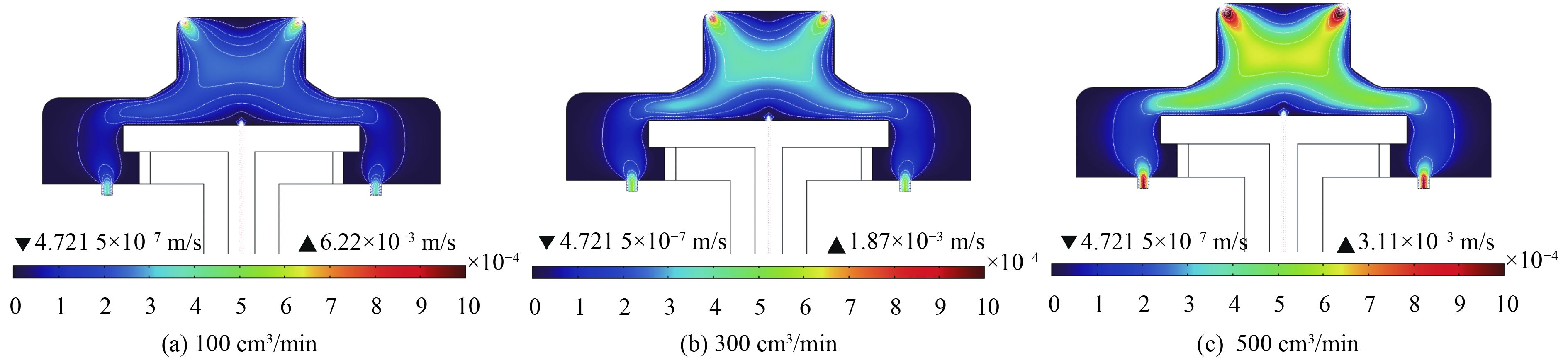
|
| 图 2 多模MPCVD装置气体流速模拟图 Figure 2 Simulation images of the gas flow field distribution |
图3为等离体光谱全谱图,插图为400~500 nm范围内OES放大图,从插图中可更好的区分CH和Hγ峰。图中可分辨的基团谱线为:Hα, Hβ, Hγ, H2, CH和C2[11-13]。从图中可知,氢气流量的上升可提高活性基团的谱线强度。

|
| 图 3 等离子体光谱全谱(插图为波长400~500 nm的放大图) Figure 3 Full OES spectra obtained at different gas flow rate (the inset was the magnified image of the OES spectra when the wavelength was 400 to 500 nm) |
图4为基团谱线强度与氢气流量的关系。从图中可知:当氢气流量从50 cm3/min上升至500 cm3/min时,Hα和C2(516.08 nm)谱线强度明显上升,Hβ,C2(471.06 nm)和C2(360 nm)谱线强度平缓上升,Hγ谱线强度微弱上升。当氢气流量超过500 cm3/min,C2 (516.08 nm)谱线强度上升依旧明显,其它基团谱线强度缓慢上升。

|
| 图 4 不同氢气流量下等离子体光谱活性基团强度 Figure 4 Chemical emission intensity of OES at different hydrogen flow rate |
氢气流量上升,等离子体的电子密度(Electron density,Ne)和电子温度(Electron temperature,Te)也会发生改变。Ne和Te是描述等离子体的两个重要参数,可通过OES光谱直接测量计算得到[14]。
其中Ne通过等离子体光谱中不同谱线的Stark展宽获得[15]。其中,Hα谱线更独立,Stark展宽更宽,且无自吸收现象[15]。因此使用Hα谱线的FWHA值(Full width at half area,FWHA),利用公式(3)[16]计算电子密度:
从图5电子密度与氢气流量关系可知:当气体流量由50 cm3/min上升至500 cm3/min时,电子密度由0.8×1019 m−3上升至2.3×1019 m−3,提高了一个数量级。气体流量持续上升,电子密度开始缓慢下降,在800 cm3/min时为1.8×1019 m−3。对比图3和图4可知:在气体流量从50 cm3/min上升至500 cm3/min过程中,Hα谱线强度和电子密度同步上升,说明电子密度值与Hα谱线强度呈正比,和其他研究者的结果一致[17]。但当气体流量继续上升时,Hα谱线强度几乎保持不变,但电子密度开始缓慢下降。气体流量超过500 cm3/min时,除C2基团以外,其它基团强度的上升速率都明显变缓,说明过高的气体流量更有利于等离子体内C2基团的形成。这是由于与H原子(13.6 eV)及H2分子(15.4 eV)相比,CxHy的离化能更低、离化面积更大[14],更容易被离化从而消耗大量电子,因此电子密度下降。

|
| 图 5 不同氢气流量下等离子体电子密度和电子温度 Figure 5 OES electron density and electron temperature at different hydrogen flow rate |
在等离子处在热力学平衡态(Thermal equilibrium,TE)时,采用Balmer-alpha和Balmer-beta两条谱线参数,利用方程(4)[18]进行等离子体电子温度的计算:
其中,I是谱线强度,λ为波长,A为跃迁几率,g为统计权重,E为激发能量,k为玻尔兹曼常数,Te为电子温度。
电子温度与氢气流量的关系如图5所示。结果表明,随着氢气流量的上升,电子温度的变化趋势与电子密度的一致。气体流量从50 cm3/min上升至500 cm3/min时,电子密度由1.02 eV上升至1.65 eV;氢气流量上升至800 cm3/min时,电子温度微弱下降至1.53 eV。电子温度大小主要受等离子体内粒子的反应和生成所影响,当有大量电子和离子生成时等离子电子温度上升[14]。因此,在氢气流量上升初期,活性基团含量上升,电子温度上升。当H2流量超过500 cm3/min时,等离子体内粒子碰撞频率过高,活性基团含量下降,电子温度开始下降。过高的氢气流量代表单位时间内进入谐振腔内的气体分子数量过多,电子与其它粒子的碰撞频率大幅上升,降低了平均自由程,无法充分加速从而没有足够的能量实现高能级离子化,因此电子温度和电子密度都在氢气流量过高的时候下降。
等离子功率吸收密度和等离子体内电子有效碰撞频率的关系可为等离子体电子密度和电子温度的变化提供理论支撑。等离子体内能量的传递主要依靠加速电子与分子的碰撞实现。假设微波电场与等离子体间的相互作用满足经典力学的要求,则等离子对微波能量的吸收密度则可通过方程(5)进行求解:
其中,Pabs为等离子微波电场功率吸收密度;q为电子电荷;m为电子质量;vm为电子与其它粒子间碰撞的碰撞频率,由于金刚石膜沉积过程中的主要气体为氢气,因此vm可用方程(6)代替:
其中,n0代表电子密度,σe代表碰撞截面,Te为电子温度,k为玻尔兹曼常数;ω为微波角频率,2.45 GHz微波频率时ω=1.5×1010 s−1。
经解析,Pabs和碰撞频率与微波角频率比值(νm/ω)的大小直接相关,其关系如图6所示。从图中知,vm/ω值上升初期,Pabs快速上升,在νm/ω值为1时获得最大值;当νm/ω继续上升,Pabs开始快速下降。νm值较小时,电子与气体分子碰撞频率较低,等离子体从微波电场中所获得的能量较低;νm值上升,则碰撞频率上升,等离子体从微波电场中所获得能量上升;νm值过高时,电子与气体分子的碰撞过于频繁,则电子无法获得足够的能量,因此Pabs开始下降。Pabs与vm变化关系为基团强度、电子密度和电子温度随气体流量变化而变化提供了理论解释和支撑。

|
| 图 6 等离子体功率吸收密度与νm/ω值的关系 Figure 6 Relationships between the OES microwave power absorption density and νm/ω value |
以基底上方2 mm中心处作为零点,对Hα,C2 (516.08 nm)和CH基团的强度进行测量,结果如图7所示。从图中可知,所有基团在基片中心处具有最高强度值。氢气流量从50 cm3/min上升至400 cm3/min时,基团强度上升明显;而氢气流量从400 cm3/min上升至800 cm3/min时,基团强度上升较慢。氢气流量较低时,基团在基底表面呈对称分布。氢气流量由50 cm3/min上升至800 cm3/min,Hα基团最高值与最低值之差由1.9×103上升至6.0×103,C2基团最高值与最低值之差由0.12×103上升至4.2×103,CH基团最高值与最低值之差由1.2×103上升至2.6×103,说明基团分布的均匀性变差。当氢气流量超过400 cm3/min时,各基团的最高强度值依旧在基片中心处,但基团出现不对称分布。其中C2基团最为明显,CH较轻,Hα最弱。说明更重的含碳基团对氢气流量改变更敏感,更容易受到其改变的影响。F.G. Celii等人[4]最早提出:基团的分布是基团扩散及气体对流共同作用的结果。研究中结合数值模拟和等离子体光谱测量2种方式对这一设想进行了证实。

|
| 图 7 不同氢气流量下基底表面活性基团的分布 Figure 7 Chemical distribution along the substrate surface with different hydrogen flow rate |
图8为金刚石膜表面中心处和距中心45 mm处的SEM形貌。在氢气流量为50 cm3/min时,基底无法被金刚石膜完整覆盖,金刚石晶粒为正六面体形,5 h后,金刚石膜依旧处在初期形核状态。比较图8(a1)(a2) 可知,中心区域的金刚石晶粒密度为1.1×10−2/μm2,是边缘区域金刚石晶粒密度(3.5×10−3/μm2)的3倍。说明低氢气流量下大面积金刚石膜生长速率较低同时无法均匀生长。当氢气流量为300 cm3/min,沉积基底被有效覆盖,中心与边缘区域没有明显不同,平均晶粒尺寸为8 μm。当气体流量为500 cm3/min时,中心区域晶粒取向杂乱,晶粒大小不一,平均晶粒尺寸为2 μm,较图8(b1) 中晶粒尺寸明显降低。图8(c2) 表明,在氢气流量为500 cm3/min时,金刚石膜的边缘区域由更细小的金刚石颗粒组成,中心与边缘区域再次出现不均匀生长现象。
金刚石膜表面形貌及均匀性主要与生长表面的基团分布相关,用肉眼观察到的等离子体区域并不是大面积金刚石膜沉积的真正有效区域[19-20]。图4和图7表明:低氢气流量下,基团分布具有较好的对称性;高氢气流量时,活性基团数目提高,基团在基片上方的均匀对称性分布被破坏。Derkaoui等人[14]对等离子体的2-D模拟结果表明,C1Hx (x=0~4)基团在等离子体中心区域的浓度比边缘区域浓度高1~2个数量级;C2Hy(y=0~6)基团在等离子体中心区域浓度比边缘区域浓度高5个数量级;H原子在等离子体中心浓度比边缘浓度高1个数量级。Mankelevich等人[21]研究表明,活性等离子体在反应过程中存在A,B,C 3个区域。其中,区域A为等离子体中心区域,温度较高;区域B和区域C为等离子体外围区域,温度较低。3个区域由于温度不同所发生的化学反应也不同:
区域A:
区域B:
区域C:
过程Ⅰ和Ⅱ的主要产物为C2Hy,97%为C2H2,与过程Ⅲ的产物一样。过程Ⅳ则是过程Ⅲ的逆反应,但过程Ⅲ在反应中每次消耗4个H原子,过程Ⅳ在反应过程中并不消耗H原子。由此可知,等离子体内的基团分布存在天然的不均匀性,但激发后由于粒子碰撞、加速以及扩散等物理运动,使得不同区域所生成的活性基团可通过以上物理运动达到基片表面的不同区域,从而实现大面积金刚石膜的均匀沉积。氢气流量上升初期,提高电子密度加强等离子体离解,提高电子温度加强等离子体活性之余,还能加速活性粒子的运动,提高大面积金刚石膜的均匀性;继续提高氢气流量,等离子体的总体活性下降,活性粒子的能量及扩散能力下降,使得大面积金刚石膜的均匀性下降。
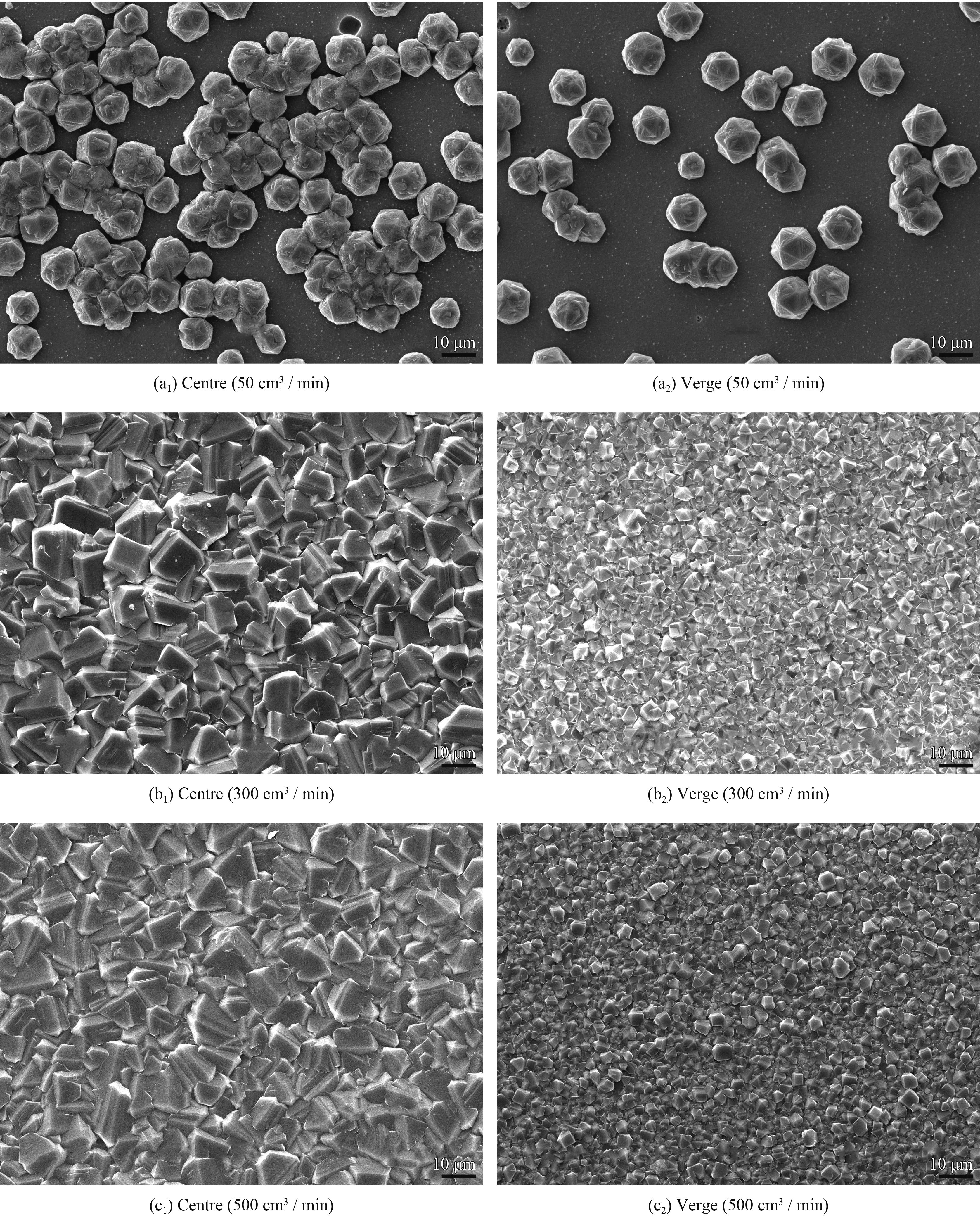
|
| 图 8 不同氢气流量下金刚石膜中心及边缘的表面形貌 Figure 8 Surface morphologies of the deposited diamond films at the centre films and verge place with different hydrogen flow rate |
图9为金刚石膜中心和边缘区域的拉曼光谱图,可分辨的拉曼峰为:1 140 cm−1处反式聚乙炔拉曼峰,1 332 cm−1处金刚石拉曼特征峰和1 560 cm−1处不定型碳拉曼峰。在气体流量为50 cm3/min时,拉曼光谱除金刚石特征峰外,还存在反式聚乙炔峰,a-1反式聚乙炔峰强度高于a-2,说明边缘区域反式聚乙炔含量比中间区域高。反式聚乙炔的存在是由于含碳基团无法有效离解吸附于金刚石晶粒表面所造成,通常在碳源气体浓度较高情况下出现[22]。但研究中所使用的甲烷浓度较低,反式聚乙炔的出现是由于气体流量过低,电子与分子的碰撞频率很低,能量传递效率低,即使在甲烷浓度很低时,也无法有效离解,于是在晶粒表面产生反式聚乙炔。同时在氢气流量为50 cm3/min时,金刚石膜仍处在初级形核状态,大量晶界暴露,因此a-1和a-2拉曼光谱图中存在不定型碳峰。气体流量为300 cm3/min时,反式聚乙炔峰和不定型碳峰消失,拉曼光谱中只存在金刚石特征峰。气体流量上升,加强了电子和分子的碰撞频率,提高等离子体的微波能量吸收密度,使含碳基团被更好的离解。氢气流量为500 cm3/min时,不定型碳石墨峰再次出现,这是由于氢气流量过高,单位时间内进入沉积腔体的气体量明显上升,原子与分子的碰撞频率过高,等离子体功率吸收密度下降,离解能下降,不定型碳拉曼峰再次出现。
金刚石膜拉曼光谱图中金刚石特征峰的半高宽值(Full width at half maximum, FWHM)是表征金刚石膜质量的重要指标之一[1],FWHM值越小则金刚石膜越好。图10为不同氢气流量下金刚石拉曼光谱半高宽值。从图中可知,随着氢气流量由50 cm3/min上升至800 cm3/min,FWHM值先下降后上升,在300 cm3/min时达到最低,为5.89 cm−1。图中误差棒的长度代表中间区域与边缘区域的FWHM值的差值,长度越短则中间与边缘区域的金刚石膜质量越接近,金刚石膜的均匀性越好;长度越长则代表中间与边缘区域金刚石膜的质量相差越大,均匀性越差。氢气流量在300 cm3/min以内时,误差棒的长度较短,金刚石膜均匀性较好,当氢气流量超过300 cm3/min时,误差棒的长度随着气体流量的上升而变长,说明金刚石膜的均匀性下降。由图9和图10可知:大面积金刚石膜的质量和均匀性都随着氢气流量的上升先上升后下降,在300 cm3/min时为最佳,这与等离子体基团分布及SEM表征结果一致。

|
| 图 9 不同氢气流量下金刚石膜不同区域拉曼光谱 Figure 9 Raman spectra at different areas of the deposited diamond films with different hydrogen flow rate |

|
| 图 10 不同氢气流量下金刚石拉曼光谱半高宽值 Figure 10 FWHM value of the deposited diamond films at different hydrogen flow rate |
图11为金刚石膜中心和边缘区域与氢气流量的关系。由图可知:氢气流量由50 cm3/min上升至300 cm3/min时,中间和边缘生长速率都随氢气流量的上升而上升。当氢气流量由300 cm3/min上升至800 cm3/min时,金刚石膜中间区域的生长速率微弱下降,但边缘区域则随着氢气流量的上升而直线下降。中间与边缘生长速率的变化不同是由于等离子体中心与边缘的基团浓度不同所造成[14],是导致金刚石膜中心与边缘区域生长速率不同的主要原因。生长速率的不同说明边缘区域对氢气流量的改变更为敏感,这与氢气流量的模拟结果一致。

|
| 图 11 金刚石膜中心和边缘处生长速率与氢气流量的关系 Figure 11 Relationships between growth rate of the diamond film at the centre and verge place |
在微波功率5.0 kW,气压15.0 kPa,CH4/H2值为2%的条件下,在直径100 mm的钼基片上进行金刚石厚膜的沉积,沉积时间为100 h。图12(a)(b)分别为大面积金刚石厚膜中心和边缘的SEM形貌,图中显示金刚石膜表面晶粒排列致密,中心和边缘的表面形貌一致。图12(c)为金刚石厚膜断面,金刚石膜断面表现出明显断面生长模式,膜厚为580 μm,则金刚石膜生长速率为5.8 μm/h。
图13(a)(b)为中心和边缘处的拉曼光谱,图中只在1 332 cm−1处存在尖锐的金刚石峰,FWHM值分别为4.39 cm−1和4.51 cm−1。图13(c)(d)分别为中心和边缘处金刚石膜XRD图谱,结果表明:中心和边缘处金刚石膜XRD图谱主要由(220)衍射峰组成,同时存在微弱的(311)和(400)峰。
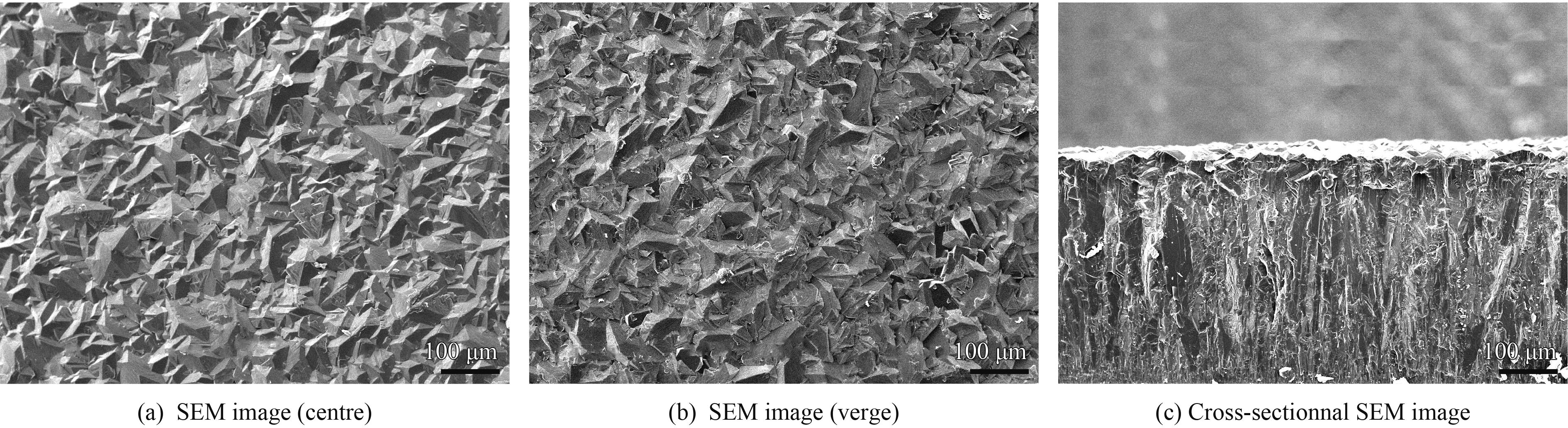
|
| 图 12 大面积金刚石膜的SEM形貌 Figure 12 SEM images of the large area diamond films |

|
| 图 13 大面积金刚石膜的拉曼光谱及XRD图谱 Figure 13 Raman spectra and XRD patterns of the large area diamond films |
(1) 新型多模MPCVD装置具有良好的流场稳定性,在高流量下气体依旧保持层流模式,在基底上方对称,均匀分布。活性基团的强度随着氢气流量的上升而增强。氢气流量在400 cm3/min内时,所有活性基团可在基底表面对称,均匀分布。
(2) 氢气流量增加,等离子体离解能量上升;氢气流量过高,等离子体离解能力下降。电子密度和温度随着氢气流量的上升先上升后缓慢下降,在500 cm3/min时达到最大,分别为2.3×1019/m3和1.65 eV。
(3) 氢气流量在中间值,300 cm3/min时,金刚石膜中心和边缘表面形貌一致。随着氢气流量的上升,FWHM值先下降后上升,在300 cm3/min时最低。氢气流量超过300 cm3/min后,中心和边缘处FWHM差值随氢气流量上升明显快速上升,金刚石膜均匀性下降。
(4) 沉积100 h后,在直径100 mm钼基片上得到均匀的大面积金刚石厚膜。中间与边缘表面形貌一致,FWHM值分别为4.39 cm−1和4.51 cm−1,生长速率为5.8 μm/h。
| [1] | MAY P W. Diamond thin films: A 21st-century material[J]. Philosophical Transactions Mathematical Physical & Engineering Sciences, 2000, 358(1766): 473-495. |
| [2] | WENG J, WANG J H, DAI S Y, et al. Preparation of diamond films with controllable surface morphology, orientation and quality in an overmoded microwave plasma CVD chamber[J]. Applied Surface Science, 2013, 276(276): 529-534. |
| [3] | TALLAIRE A, KASU M, UEDA K, et al. Origin of growth defects in CVD diamond epitaxial films[J]. Diamond & Related Materials, 2008, 17(1): 60-65. |
| [4] | CELII F G, JR D W, PURDES A J. Deposition of smooth, oriented diamond films using microwave plasma chemical vapor deposition[J]. Thin Solid Films, 1992, 212(1-2): 140-149. |
| 点击浏览原文 | |
| [5] | RALCHENKO V, SYCHOV I, VLASOV I, et al. Quality of diamond wafers grown by microwave plasma CVD: Effects of gas flow rate[J]. Diamond & Related Materials, 1999, 8(2-5): 189-193. |
| 点击浏览原文 | |
| [6] | CHEN W, LU X, YANG Q, et al. Effects of gas flow rate on diamond deposition in a microwave plasma reactor[J]. Thin Solid Films, 2006, 515(4): 1970-1975. |
| 点击浏览原文 | |
| [7] | SU J, LI Y, LIU Y, et al. Revisiting the gas flow rate effect on diamond films deposition with a new dome-shaped cavity type microwave plasma CVD reactor[J]. Diamond & Related Materials, 2017, 73: 99-104. |
| 点击浏览原文 | |
| [8] | STEMSCHULTE H, BAUER T, SCHRECK M, et al. Comparison of MWPCVD diamond growth at low and high process gas pressures[J]. Diamond & Related Materials, 2006, 15(4): 542-547. |
| [9] | MA J, CHEESMAN A, ASHFOLD M N R, et al. Quantum cascade laser investigations of CH4 and C2H2 interconversion in hydrocarbon/H2 gas mixtures during microwave plasma enhanced chemical vapor deposition of diamond[J]. Journal of Applied Physics, 2009, 106(3): 113304-581. |
| [10] |
马志斌, 吴建鹏, 陶利平, 等. MPCVD等离子体的发射光谱研究[J]. 光谱学与光谱分析, 2013, 33(9): 2562-2565.
MA Z B, WU J P, TAO L P, et al. Optical emission spectroscopy of MPCVD plasma[J]. Spectroscopy and Spectral Analysis, 2013, 33(9): 2562-2565 (in Chinese) |
| 点击浏览原文 | |
| [11] | HEMAWAN K W, HEMLEY R J. Optical emission diagnostics of plasmas in chemical vapor deposition of single-crystal diamond[J]. Journal of Vacuum Science & Technology A, 2015, 33(6): 1-6. |
| [12] | MALLIK A K, BYSAKH S, DUTTA S, et al. Correlation between optical emission spectra and the process parameters of a 915 MHz microwave plasma CVD reactor used for depositing polycrystalline diamond coatings[J]. Sadhana, 2014, 39(4): 957-970. |
| 点击浏览原文 | |
| [13] | MA J, ASHFOLD M N R, MANKELEVICH Y A. Validating optical emission spectroscopy as a diagnostic of microwave activated CH4/Ar/H2 plasmas used for diamond chemical vapor deposition[J]. Journal of Applied Physics, 2009, 105(4): 1489-581. |
| [14] | DERKAOUI N, ROND C, GRIES T, et al. Determining electron temperature and electron density in moderate pressure H2/CH4 microwave plasma[J]. Journal of Physics D Applied Physics, 2016, 47(20): 205201. |
| [15] | SHERBINI A M E, SHERBINI T M E, HEGAZY H, et al. Evaluation of self-absorption coefficients of aluminum emission lines in laser-induced breakdown spectroscopy measurements[J]. Spectrochimica Acta Part B Atomic Spectroscopy, 2005, 60(12): 1573-1579. |
| 点击浏览原文 | |
| [16] | SHERBINI A M E, HEGAZY H, SHERBINI T M E. Measurement of electron density utilizing the Hα -line from laser produced plasma in air[J]. Spectrochimica Acta Part B, 2006, 61: 532-539. |
| 点击浏览原文 | |
| [17] | BOLSHAKOV A P, RALCHENKO V G, YUROV V Y, et al. High-rate growth of single crystal diamond in microwave plasma in CH4/H2 and CH4/H2/Ar gas mixtures in presence of intensive soot formation[J]. Diamond & Related Materials, 2016, 62(1395): 49-57. |
| [18] | NAVEED M A, REHMAN N U, ZEB S, et al. Langmuir probe and spectroscopic studies of RF generated helium-nitrogen mixture plasma[J]. European Physical Journal D, 2008, 47(3): 395-402. |
| 点击浏览原文 | |
| [19] | BRINKMAN E A, STALDER K R, JEFFRIES J B. Electron densities and temperatures in a diamond-depositing direct-current arcjet plasma[J]. Journal of Applied Physics, 1997, 81(3): 1093-1098. |
| 点击浏览原文 | |
| [20] | MAHONEY E J D, TRUSCOTT, ASHFOLD M N R et al. Optical emission from C2-anions in microwave-activated CH4/H2 plasma for chemical vapor depostion of diamond[J]. The Journal of Physical Chemical A, 2017, 121: 2760-2772. |
| 点击浏览原文 | |
| [21] | MANKELEVICH Y A, ASHFOLD M N R, MA J. Plasma-chemical processes in microwave plasma-enhanced chemical vapor deposition reactors operating with C/H/Ar gas mixtures[J]. Journal of Applied Physics, 2008, 104(11): 473. |
| [22] | SUN Q, WANG J, WENG J, et al. Surface structure and electric properties of nitrogen incorporated NCD films[J]. Vacuum, 2017, 137: 155-162 |
| 点击浏览原文 |



