2. 哈尔滨工业大学 先进焊接与连接国家重点实验室,哈尔滨 150001
2. State Key Laboratory of Advanced Welding and Joining, Harbin Institute of Technology, Harbin 150001
电弧离子镀方法可以获得包括碳离子在内的几乎所有金属离子,同时还以高离化率、绕射性好、涂层质量好及沉积效率高等优点而受到广泛重视,即使非规则零部件也可以实现薄膜的快速沉积。不仅可以用于制备金属防护涂层,还可以通过工艺方法的调节,实现氮化物、碳化物等高温陶瓷涂层的制备,甚至可应用到制备纳米多层膜和超晶格薄膜中[1-3]。
但是电弧离子镀技术存在严重限制其推广应用的“大颗粒(Macroparticles,MPs)”缺陷对薄膜污染的问题。由于电弧离子镀过程中弧斑运动是不确定的,能量在靶面的集中点也在不断变化,引起等离子体起始位置的变动,导致大颗粒在不同的位置持续的产生[4-9]。Anders通过分析大颗粒在空间传输过程中等离子体与大颗粒之间物质和能量传递发现,使大颗粒到达基体之前完全蒸发的难度较大,当大颗粒温度达到强蒸发区域时,离子轰击的加热效应会因热电子发射效应而削弱,而微波加热则被等离子体的屏蔽效应隔绝,虽然可以通过利用红外激光器来使大颗粒蒸发,但是代价比较高[10]。郭慧梅等人[11]利用Edelberg和Aydli的一维等离子体鞘层模型[12]分析了大颗粒在等离子体鞘层中的带电和受力情况,通过脉冲偏压参数的变化,使电场的排斥力大于重力和离子拖曳力之和,进而起到对大颗粒的净化作用。在大颗粒的空间运动过程中,除了受到自身的重力、等离子体的离子拖曳力、电场的排斥力等一系列作用,引起空间运动速度和方向的变化,导致其在不同空间位置的分布状态产生差异之外,在基体与靶表面之间还存在一个温度梯度,大颗粒在与温度梯度降低的方向上受到气体热泳力的作用。
文中采用尘埃等离子体的相关理论对电弧等离子体中大颗粒空间传输过程的受力特征进行分析和解释,以为电弧离子镀在清除大颗粒缺陷方面的工艺改进提供相关的参考。
1 大颗粒在等离子体中的空间受力根据尘埃等离子体的理论,结合电弧离子镀等离子体的典型特征,在电弧离子镀等离子体中,大颗粒主要受到4种力的共同作用[10]:大颗粒的自身重力Fg、离子拖曳力Fi、电场力Fe和热泳力Fth,如图1所示,其中重力Fg方向向下,离子拖曳力Fi拖动大颗粒指向基体方向,电场力Fe排斥大颗粒远离基体方向,热泳力Fth方向取决于温度梯度,由弧源指向基体。

|
| 图 1 大颗粒空间受力模型示意图 Figure 1 Schematic diagram of spatial force model of macroparticle |
在电弧离子镀沉积过程中,大颗粒在能量密集的弧斑处产生。由于大颗粒尺寸的差异,引起质量的变化,所受的重力发生改变,其所受重力的表达式为:
其中mMP表示大颗粒的质量,g表示重力加速度,RMP表示大颗粒的半径,ρMP表示大颗粒的密度。根据对大颗粒尺寸的统计分析,不同直径的大颗粒受到的重力如图2所示,Ti大颗粒密度取值为ρMP=4.51×10−15 kg·μm−3,其重力的取值范围为5.233×10−18~4.186×10−11 N·μm−3。
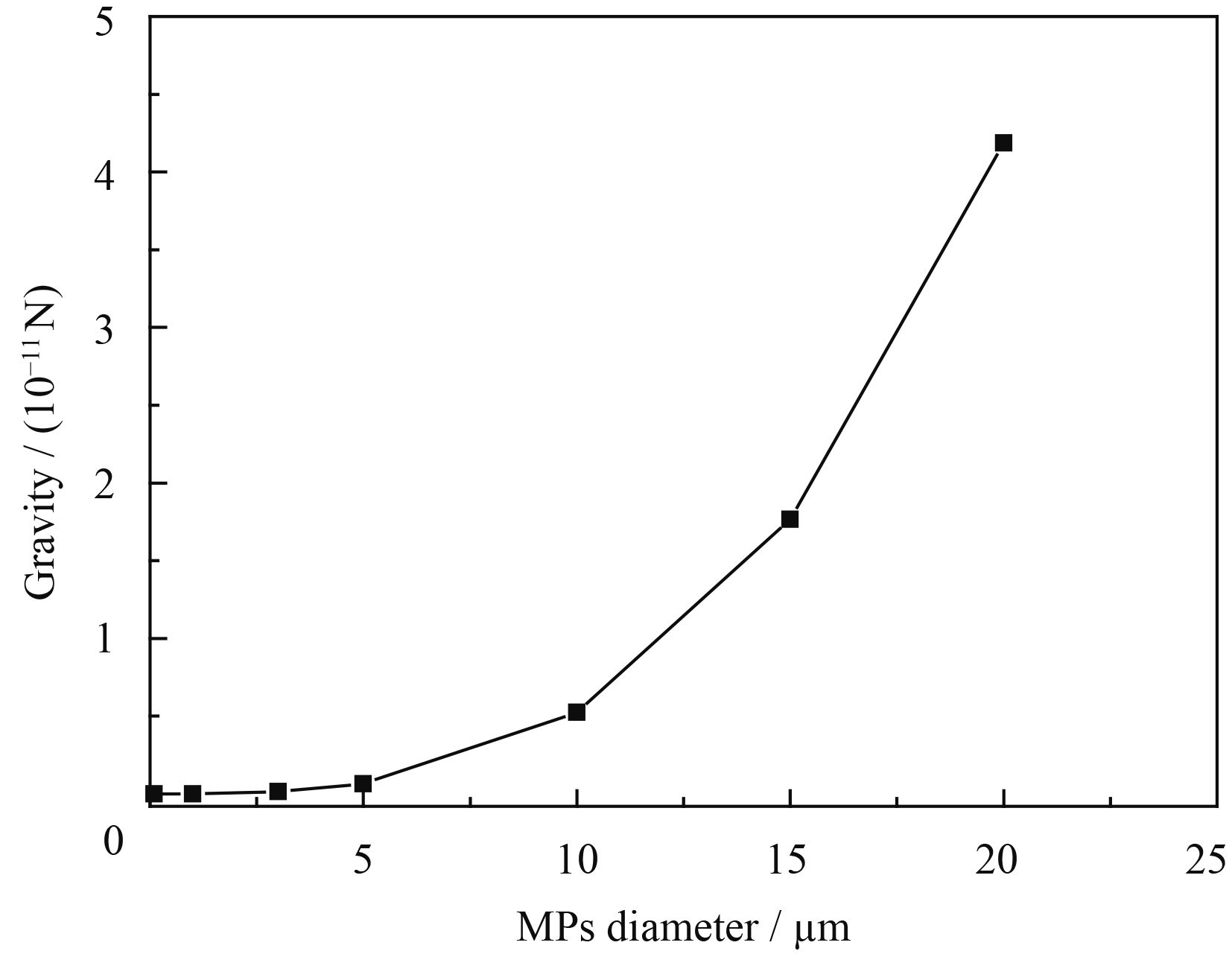
|
| 图 2 不同直径大颗粒受到的重力 Figure 2 Gravity of different diameter MPs |
在电弧离子镀等离子体中,由于大颗粒处于等离子体的包围当中,各种粒子与大颗粒发生碰撞,带有正电荷的离子和负电荷的电子向大颗粒发生了电荷转移,大颗粒一直处于充电状态。在等离子体传输过程中,电子的热速度远远大于离子的热速度,因此大颗粒受到电子的碰撞几率比离子的大很多。当对大颗粒充电过程达到稳定状态时,在大颗粒表面将出现过剩的电子,大颗粒所带的电荷状态为负电荷,其带电量的表达公式为:
公式(2)中UMP表示大颗粒的表面悬浮电位,CMP表示大颗粒的电容值。
在等离子体中,德拜长度的表达式为[10]:
公式(3)中ε0表示真空介电常数,一般其值选取为8.854 2×10−12 F·m−1,k表示玻尔兹曼常数,Te表示电子温度,ne表示电子密度,e表示电子电荷。将已知变量值代入公式,可以得到德拜长度λD,其取值的范围如图3所示。

|
| 图 3 德拜长度和平均电子密度的关系 Figure 3 Relationship between Debye length and average electron density |
由于大颗粒的半径RMP属于微米量级,远小于电弧等离子体的德拜长度λD的毫米量级,在等离子体中可以将大颗粒当作一个球形电容,其电容值可以表达为[10]:
电容与大颗粒半径之间的关系如图4所示,随着大颗粒半径从0.1 μm增加到10 μm,电容值也从1.112×10−17 F增加到1.112×10−15 F。结合公式(2)和(4),大颗粒带电量公式(2)可以表示为:
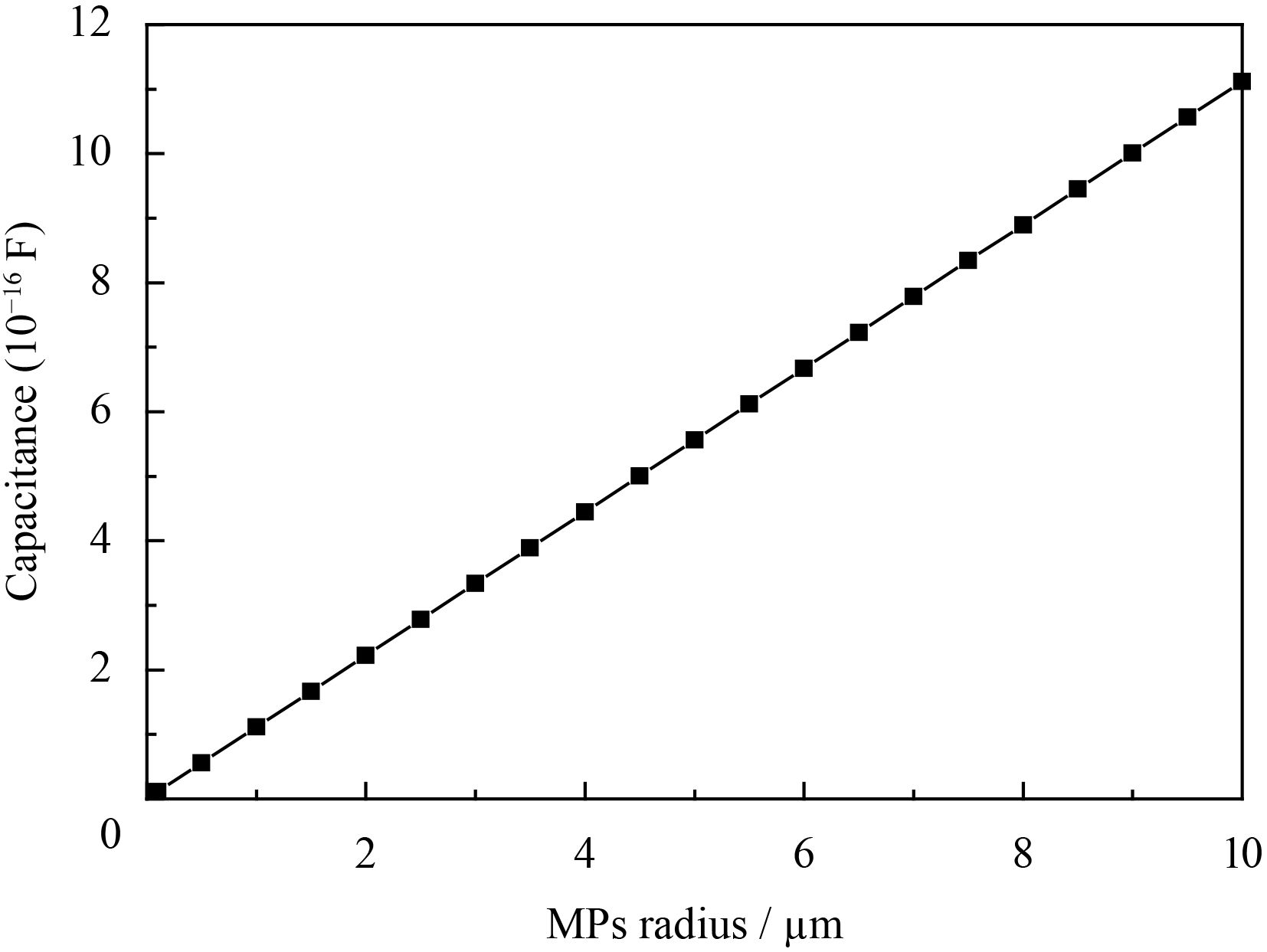
|
| 图 4 电容和大颗粒半径之间的关系 Figure 4 Relationship between capacitance and MPs radius |
对于电弧等离子体,相关的研究一般根据电流平衡方程来获得大颗粒的表面悬浮电位,在大颗粒表面的电流平衡方程为[11, 13-14]:
公式(6)中的IeMP(UMP, x)表示大颗粒表面的电子流密度,IiMP(UMP, x)表示大颗粒表面的离子流密度,x表示大颗粒在鞘层中的位置。
根据Orbit motion limited充电理论,到达大颗粒表面的电子和离子产生的电流分别为[13, 15]:
其中,n0表示等离子体的密度,将电子电流IeMP(UMP, x)和离子电流IiMP(UMP, x)的表达式代入到电流平衡方程中,则公式(6)可以转换为:
对公式(9)进行移项和化简,得到大颗粒表面悬浮电势求解方程为:
再对公式(10)两侧同时对大颗粒的表面悬浮电势UMP取微分,即对大颗粒的表面悬浮电势求解一阶导数,则公式(10)可以化为:
经过对大颗粒的表面悬浮电势UMP求导之后,可以得到:
再对公式(12)经过移项化简,方程可以转化为
然后对公式(13)两边同时以e为底,取自然对数ln,来进一步求解大颗粒的表面悬浮电势UMP,可以得到:
对公式(14)进行移项化简推导,大颗粒表面悬浮电势UMP表达式为[10]:
公式(15)中me和mi分别表示电子和离子的质量,电子质量me=9.1×10−31 kg,Ti离子的质量mi=7.95×10−26 kg;电子的带电量e=1.6×10−19 C,uB表示Bohm速度,其计算表达式为

|
| 图 5 大颗粒悬浮电位与离子速度和平均电子密度的关系 Figure 5 Floating potential of MPs as a function of ion velocity and average electron density |
根据公式(5),可以获得不同大颗粒带电量和电容值与带电量的关系,如图6所示。随着电容的增大,即大颗粒尺寸的增加,所带的负电荷逐渐增多。依据图4的结果和公式(5)发现,大颗粒的带电量随着电容和悬浮电位的增加而增大,最大值可以达到3.4×10−16~4.6×10−14 C。

|
| 图 6 大颗粒带电量与大颗粒电容值和悬浮电位的关系 Figure 6 MPs electrified capacity as a function of MPs capacitance and floating potential |
由于电弧离子镀的离化率很高,对于较高的离化率,大颗粒在等离子体鞘层中受到的电场力不可忽略。根据所带电荷和空间场强不同,大颗粒受到的电场力表达式为[10]:
公式(16)中E表示大颗粒所处空间的电场强度,文献[11]所采用的脉冲偏压幅值为−1 200~−300 V,基体附近0~500 μm处电场强度的分布曲线,选择电场强度的变化范围为−600~0 V·m−1。由于大颗粒带负电荷,在基体上施加了脉冲负偏压,当带负电的大颗粒接近基体时,将受到远离基体的电场力作用,而被排斥。由于受到的电场力方向远离基体表面,减少了大颗粒在基体表面的沉积概率。同时由于脉冲偏压的周期性变化,使基体附近的等离子体鞘层发生振荡,电场强度也发生变化。随着基体周围周期变化的等离子体鞘层和鞘层位置处电场强度的变化,大颗粒受到的电场力也发生相应的变化。在基体附近,空间的电场强度为[10]:
将空间电场强度公式(17)代入到大颗粒所受电场力公式(16),可以得到电场力的表达式为[10]:
由于大颗粒的尺寸不同,会引起其带电量发生变化,进而也会对电场力产生影响。随着大颗粒与基体的距离减小,空间电场强度逐渐增加,电场排斥力也逐渐增加。随着大颗粒尺寸的增加,电容量增大,所带负电荷数目也增加,则所受到的电场力也随着大颗粒尺寸增加而增大,结果如图7所示,基体偏压电场对于大颗粒的电场力变化范围为0~2.8×10−11 N。

|
| 图 7 不同尺寸大颗粒电场力与带电量和电场强度的关系 Figure 7 MPs electric field force as a function of electrified capacity and electric field strength with different radius |
在电弧离子镀沉积薄膜的过程中,由于离化率很高,等离子体的密度相比于其他方法其密度也很高。电弧等离子体中的离子流主要通过3种方式来实现对大颗粒运动传输过程的作用:① 离子流通过与大颗粒的直接空间碰撞,来将自身所带的动量转移给大颗粒;② 离子流与带电的大颗粒在电场力的作用下,产生带电粒子之间的库伦碰撞来实现动量转移,即离子拖曳力或者库伦拖曳力,实现对大颗粒运动方向和状态的影响;③ 离子产生类似流体的效应,来改变和扭曲大颗粒表面的德拜鞘层,使其处于非平衡的状态,进而对带电的大颗粒产生作用,影响其运动过程[10]。
当电弧等离子体的离子进入到基体的等离子体鞘层时,其离子运动速度可达到1×104~3×104 m·s−1的数量级[17, 19],在鞘层中形成了离子的动量流,其表达式为[10]:
公式(19)中

|
| 图 8 不同离子密度和离子运动速度与动量流的关系 Figure 8 Momentum flow as a function of ion density and ion velocity |
根据距离的变化,离子流向大颗粒的动量传递密度σcoll的表达式为[10]:
公式(20)中b表示离子的碰撞参数,由于离子对大颗粒的直接碰撞产生的离子拖曳力,bcoll为碰撞积分的最低极限,其表达式分别为[10]:
对公式(20)bcoll进行积分,选择德拜长度λD为最高积分极限。相比于离子的热速度,离子的运动速度较高,导致大颗粒表面不能形成鞘层。
公式(20)经过积分,动量传递密度σcoll可以表达为[10]:
其中
在鞘层的外区域,库伦力的聚焦效应非常重要,假定离子拖曳力的动量流传递截面与离子放电电流截面相同,则离子拖曳力表达为[10]:
由于离子速度vi数量级为104 m·s−1,大颗粒悬浮电位UMP数量级为10 V,因此离子拖曳力的表达式(25)可以化为[10]:
结合大颗粒的带电量和电容之间的公式(5),可将离子拖曳力公式(26)转化为[10]:
结合不同尺寸大颗粒电容量和动量流的计算结果,将公式(19)和公式(4)代入到公式(27)计算可以得到离子拖曳力与大颗粒电容和动量流之间的关系,结果如图9所示。发现离子拖曳力的变化范围约为2.4959×10−15~6.7389×10−10 N。随着大颗粒尺寸的增加,受到的离子动量流碰撞作用加强,大颗粒的电容量增大,所产生的离子拖曳力也逐渐增加,有助于大颗粒在薄膜表面的粘附,使薄膜表面的大颗粒缺陷数目增多[21]。特别是尺寸较大的大颗粒,更容易受到离子拖曳力的影响而改变运动方向或者直接附着在薄膜表面。

|
| 图 9 离子拖曳力与大颗粒电容量和离子动量流的关系 Figure 9 Ion drag force as a function of MPs electrified capacity and ion momentum flow |
在电弧等离子体中,虽气体受到等离子体的作用程度不同,但仍存在未电离的气体。由于空间位置不同,在基体与靶表面之间存在一个温度梯度,大颗粒将会在气体温度梯度相反的方向上受到一种力,即热泳力,其表达式为[13, 22]:
公式(28)中ΔTn表示气体的温度梯度,由于靶表面的温度一般都在2 000 K以上,在沉积薄膜时,真空室的温度保持在500 K左右,而靶表面到基体之间的工作距离一般都在0.15~0.4 m,因此ΔTn=3.75×103~10×103 K·m−1,λtrans表示气体热传导系数,气体的最大热传导系数0.017 3 m·kg·s−3。随着工作距离的变化,相应的温度梯度的变化如图10所示。
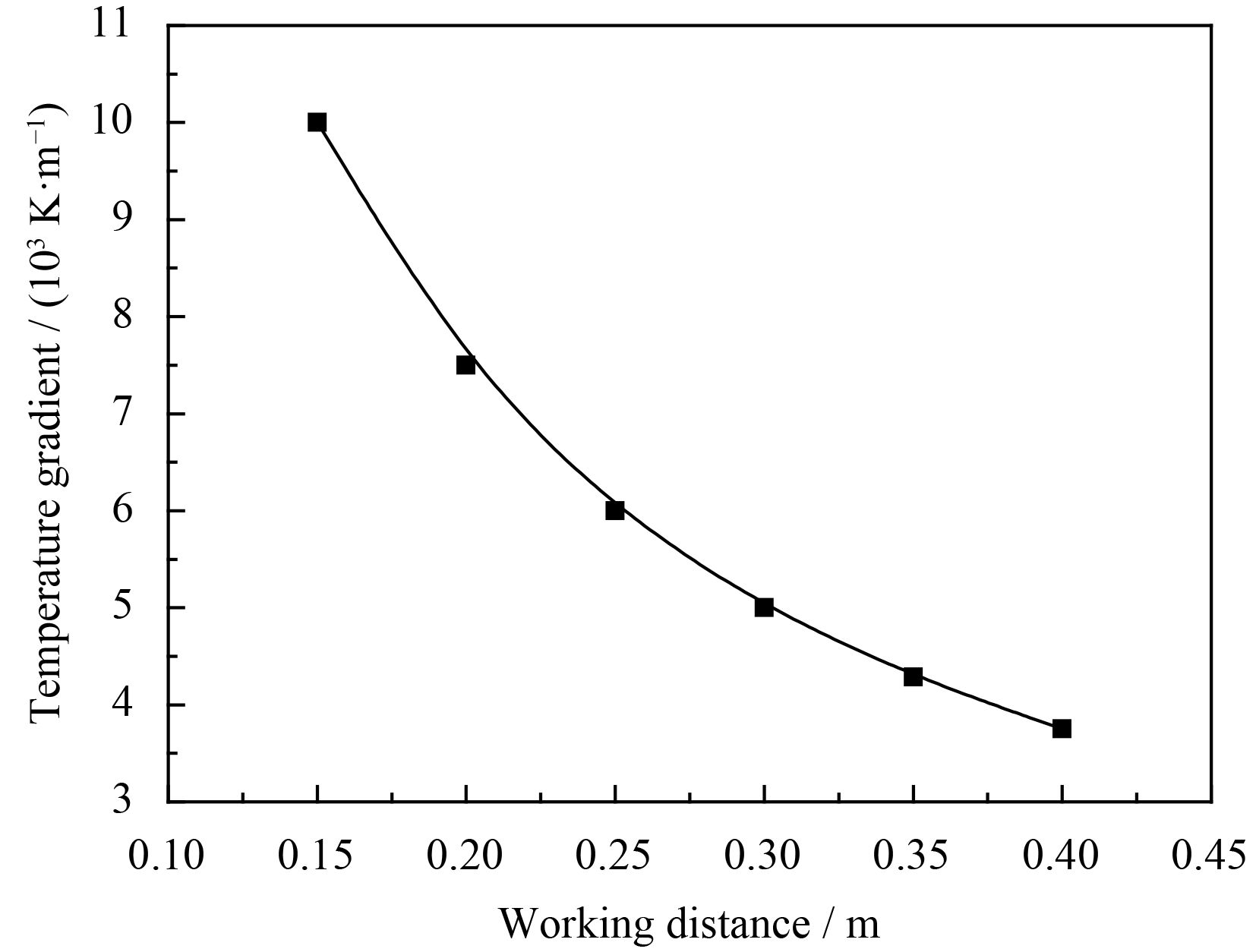
|
| 图 10 温度梯度和工作距离的关系 Figure 10 Relationship between temperature gradient and working distance |
公式(28)中vth表示气体的热速度,其表达式为[13]:
公式(29)中mN表示氮气分子的质量,其值为4.64×10−26 kg,代入公式(29),可以得到气体的热速度vth≈545 m·s−1。当大颗粒的温度低于500 K时,其对于热泳力的效应可以忽略。根据试验发现大颗粒在薄膜表面以扁平状形貌存在,说明在与基体碰撞时,其物态处于半固态或液态,温度明显高于500 K,其热泳力不可忽略。将已知变量和计算变量代入公式(28),可以获得温度梯度和大颗粒尺寸与热泳力的对应关系,结果如图11所示。随着大颗粒尺寸和工作距离引起的温度梯度增加,相应的热泳力也逐渐增大,其绝对值的变化范围为2.25×10−15~6×10−11 N。

|
| 图 11 热泳力与大颗粒尺寸和温度梯度的对应关系 Figure 11 Thermophoretic force as a function of MPs radius and temperature gradient |
作用在大颗粒上的电场力、离子拖曳力、热泳力和重力的峰值与距离基体表面的距离密切相关,对于带负电的大颗粒有一个稳定的悬浮力。在远离基体的等离子体中,大颗粒主要受到重力、热泳力和离子拖曳力的作用,其中当大颗粒尺寸为5 μm以下时[4-7],主要是热泳力和离子拖曳力起主导作用;而当接近基体,离子密度降低,在等离子体鞘层作用范围内,主要的作用力是电场力,热泳力、和离子拖曳力的作用减弱。重力对于大颗粒的作用主要取决于大颗粒的尺寸,并且在远离基体等离子体鞘层区域,当大颗粒尺寸到达5 μm以上时,主要是重力、热泳力和离子拖曳力的作用。
以粒径为5 μm的大颗粒为例,依据公式(1)其重力为2.313×10−11 N;依据公式(27)其离子拖曳力约为1.56×10−12~4.213×10−11 N;当其到达基体表面附近时,依据公式(5)和(15)大颗粒的带电量约为1.668×10−14~2.335×10−14 C,当电场强度在500 V·m−1以上时,再依据公式(18)其电场力约为8.34×10−12~1.168×10−11 N;依据公式(28)其受到的热泳力约为6.25×10−12~1.5×10−11 N,受到的4种力的大小分别为:重力Fg>电场力Fe>热泳力Fth,离子拖曳力Fi与等离子体的密度有关,重力Fg+离子拖曳力Fi+热泳力Fth>电场力Fe。要使到达基体大颗粒受到有效负偏压对其的排斥作用,必须增加偏压电场的强度。因此,通过在基体上施加脉冲负偏压,当外部偏压电场增加到一定程度,到达薄膜表面和膜层中的大颗粒数目大量的减少,根据Child定律,电场排斥力效应作用明显。
如果以粒径为3 μm的大颗粒为例,依据公式(1)其重力为1.413×10−13 N;依据公式(27)其离子拖曳力约为2.247×10−13~6.066×10−11 N;当其到达基体表面附近时,依据公式(5)和(15)大颗粒的带电量约1.0×10−14~1.4×10−14 C,当电场强度在400 V·m−1以上时,再依据公式(18)其电场力约为4×10−12~5.6×10−12 N;依据公式(28)其受到的热泳力约为2.025×10−12~5.4×10−12 N,受到的4种力的大小分别为:电场力Fe>热泳力Fth>重力Fg,离子拖曳力Fi仍然和等离子体的密度有关,电场力Fe>重力Fg+热泳力Fth。结合之前的研究结果[4-7]发现:对于粒径3 μm以下的大颗粒,其占沉积到薄膜表面的大颗粒数目的85%以上,当施加脉冲偏压占空比40%,幅值−400 V左右时,与不加偏压时相比,大颗粒的数目减少量高达70%。
另外,由于大颗粒速度的随机分布,部分大颗粒所带的动能较大,即使有电场力的排斥作用,也不足以抵消自身的动能,仍然会有一些大颗粒到达基体表面,与基体发生剧烈的塑性碰撞,并粘附在基体表面,呈现典型的扁平状形貌。当基体表面与靶表面垂直放置时,扁平的长条状形貌在薄膜表面出现。只有当脉冲负偏压电场产生的排斥力可以克服大颗粒本身的动能时,才可以有效的减少大颗粒在薄膜表面的沉积概率。
3 结 论(1) 利用尘埃等离子体的相关经典理论和电弧离子镀等离子体的相关参数,对电弧离子镀中大颗粒的空间传输受力特征进行了计算分析。在电弧等离子体传输过程中,大颗粒受到大颗粒的自身重力Fg、离子拖曳力Fi、电场力Fe和热泳力Fth等4种力的共同作用。离子拖曳力的变化范围约为2.495 9×10−15~6.738 9×10−10 N,热泳力绝对值的变化范围为2.25×10−15~6×10−11 N,基体偏压电场强度选择−600~0 V·m−1,对于大颗粒的电场力变化范围为0~2.8×10−11 N,重力大小取决于大颗粒的粒径尺寸。
(2) 根据大颗粒尺寸和空间位置等离子体特征参数的差别,4种力在传输的不同阶段起主导作用,在等离子体空间传输过程,主要受到离子拖曳力作用;在距离基体附近,出现基体负偏压对大颗粒的电场力作用;重力和热泳力始终都对大颗粒有作用,二者的大小取决于大颗粒尺寸和温度梯度。
(3) 由于大颗粒具有一定的传输速度,除了电场力对大颗粒的排斥作用超过其他3种力之外,电场力还需要克服大颗粒自身动能时,才可以有效的降低大颗粒沉积到薄膜表面的数目。
| [1] |
史鑫, 戴剑锋, 吴贵智, 等. 多弧离子镀沉积Ti/TiN多层薄膜的摩擦磨损及电化学性能[J]. 中国表面工程, 2016, 29(3): 20-25.
SHI X, DAI J F, WU G Z, et al. Tribological and electrochemical properties of Ti/TiN multilayer film prepared by multi-arc ion plating[J]. China Surface Engineering, 2016, 29(3): 20-25 (in Chinese). |
| 点击浏览原文 | |
| [2] |
耿东森, 吴正涛, 聂志伟, 等. 基体偏压对电弧离子镀AlCrSiON涂层结构和热稳定性的影响[J]. 中国表面工程, 2016, 29(6): 60-66.
GENG D S, WU Z T, NIE Z W, et al. Influence of substrate bias on microstructure and thermal stability of AlCrSiON coatings deposited by arc ion plating[J]. China Surface Engineering, 2016, 29(6): 60-66 (in Chinese). |
| 点击浏览原文 | |
| [3] |
赵彦辉, 郭朝乾, 杨文进, 等. 轴向磁场对电弧离子镀TiN薄膜组织结构及力学性能的影响[J]. 中国表面工程, 2015, 28(1): 56-61.
ZHAO Y H, GUO C Q, YANG W J, et al. Effects of axial magnetic field on microstructure and mechanical properties of TiN films deposited by arc ion plating[J]. China Surface Engineering, 2015, 28(1): 56-61 (in Chinese). |
| 点击浏览原文 | |
| [4] |
魏永强, 刘建伟, 文振华, 等. 脉冲偏压占空比和放置状态对大颗粒分布规律的影响[J]. 热加工工艺, 2015, 44(4): 134-137.
WEI Y Q, LIU J W, WEN Z H, et al. Influence of pulsed bias duty cycle and placement state on distribution rule of macroparticles[J]. Hot Working Technology, 2015, 44(4): 134-137 (in Chinese). |
| 点击浏览原文 | |
| [5] |
魏永强, 魏永辉, 蒋志强, 等. 放置方向和沉积时间对Ti大颗粒分布状态的影响[J]. 表面技术, 2014, 43(5): 6-10, 41.
WEI Y Q, WEI Y H, JIANG Z Q, et al. Influence of placement orientation and deposition time on the morphology and distribution of Ti macroparticles[J]. Surface Technology, 2014, 43(5): 6-10, 41 (in Chinese). |
| 点击浏览原文 | |
| [6] |
魏永强, 魏永辉, 蒋志强, 等. 基体放置状态与脉冲偏压幅值对大颗粒形貌和分布的影响规律[J]. 真空科学与技术学报, 2014, 34(10): 1021-1028.
WEI Y Q, WEI Y H, JIANG Z Q, et al. Influence of placement state and pulsed bias voltage on the morphology and distribution of macroparticles[J]. Chinese Journal of Vacuum Science and Technology 2014, 34(10): 1021-1028 (in Chinese). |
| 点击浏览原文 | |
| [7] |
魏永强, 贾爱芹, 蒋志强, 等. 靶基间距对电弧离子镀中大颗粒形貌和分布的影响[J]. 金属热处理, 2014, 39(7): 130-134.
WEI Y Q, JIA A Q, JIANG Z Q, et al. Influence of distance between target and substrate on morphology and distribution of macroparticles during arc ion plating[J]. Heat Treatment of Metals, 2014, 39(7): 130-134 (in Chinese). |
| 点击浏览原文 | |
| [8] |
魏永强, 文振华, 蒋志强, 等. 大颗粒缺陷在电弧离子镀所制备薄膜中的分布状态研究[J]. 真空, 2013, 50(6): 7-10.
WEI Y Q, WEN Z H, JIANG Z Q, et al. Research of macroparticles distribution in the films prepared by arc ion plating[J]. Vacuum, 2013, 50(6): 7-10 (in Chinese). |
| 点击浏览原文 | |
| [9] |
魏永强, 巩春志, 田修波, 等. 阴极弧径向不同位置膜层性能分布规律[J]. 稀有金属材料与工程, 2009, 38(5): 788-793.
WEI Y Q, GONG C Z, TIAN X B, et al. Uniformity of thickness and surface properties of TiN films deposited by vacuum arc[J]. Rare Metal Materials and Engineering, 2009, 38(5): 788-793 (in Chinese). |
| 点击浏览原文 | |
| [10] | Anders A. Growth and decay of macroparticles: A feasible approach to clean vacuum arc Plasmas?[J]. J Appl Phys, 1997, 82(8): 3679-3688. |
| 点击浏览原文 | |
| [11] |
郭慧梅, 林国强, 盛明裕, 等. 大颗粒在等离子体鞘层中的受力分析与计算[J]. 金属学报, 2004, 40(10): 1064-1068.
GUO H M, LIN G Q, SHENG M Y, et al. Analysis and calculation of forces on macroparticles in Plasma sheath[J]. Acta Metallurgica Sinica, 2004, 40(10): 1064-1068 (in Chinese). |
| 点击浏览原文 | |
| [12] | EDELBERG E A, AYDIL E S. Modeling of the sheath and the energy distribution of ions bombarding rf-biased substrates in high density plasma reactors and comparison to experimental measurements[J]. J Appl Phys, 1999, 86(9): 4799-4812. |
| 点击浏览原文 | |
| [13] | NITTER T. Levitation of dust in RF and dc glow discharges[J]. Plasma Sources Sci Technol, 1996, 5(1): 93-111. |
| [14] |
侯璐景, 王友年. 尘埃颗粒在射频等离子体鞘层中的非线性共振现象的理论研究[J]. 物理学报, 2003, 52(2): 434-441.
HOU L J, WANG Y N. Theoretical study on nonlinear resonances of a charged micro-particle in a RF sheath [J]. Acta Ppysica Sinica, 2003, 52(2): 434-441 (in Chinese). |
| [15] | ALLEN J E. Probe theory-the orbital motion approach [J]. Phys Scripta, 1992, 45(5): 497-503. |
| 点击浏览原文 | |
| [16] | ANDERS A. Fundamentals of pulsed plasmas for materials processing[J]. Surface & Coating Technology, 2004, 183(2/3): 301-311. |
| [17] | TAY B K, ZHAO Z W, CHUA D H C. Review of metal oxide films deposited by filtered cathodic vacuum arc technique[J]. Materials Science & Engineering R, 2006, 52(1/2/3): 1-48. |
| [18] | KUTZNER J, GLINKOWSKI M. Electron temperature and probe floating potentials in a plasma of the low-current vacuum arc[J]. IEEE Transactions on Plasma Science, 1983, 11(3): 233-238. |
| 点击浏览原文 | |
| [19] | KUTZNER J, MILLER H C. Integrated ion flux emitted from the cathode spot region of a diffuse vacuum arc[J]. Journal of Physics D Applied Physics, 1992, 25(4): 686-693. |
| 点击浏览原文 | |
| [20] |
李争显, 张树林, 袁哲, 等. 多弧离子镀中真空等离子体静电探针诊断方法的研究[J]. 真空, 1994, 4: 25-29, 10.
LI Z X, ZHANG S L, YUAN Z et al. Study on electric probe diagnoses of vacuum plasma in multi-arc ion plating [J]. Vacuum, 1994, 4: 25-29, 10 (in Chinese). |
| 点击浏览原文 | |
| [21] |
林永清, 巩春志, 魏永强, 等. 脉冲偏压对矩形平面大弧源离子镀TiN膜层性能的影响[J]. 材料研究学报, 2008, 22(4): 399-404.
LIN Y Q, GONG C Z, WEI Y Q, et al. Influence of pulse bias on surface properties TiN films fabricated by arc ion plating with large rectangle targets[J]. Chinese Journal of Materials Research, 2008, 22(4): 399-404 (in Chinese). |
| 点击浏览原文 | |
| [22] | HAVNES O, NITTER T, TSYTOVICH V, et al. On the thermophoretic force close to walls in dusty plasma experiments[J]. Plasma Sources Science & Technology, 1994, 3(3): 448-451. |



